Полупроводниковые пленки из четырех и более компонентных сплавов элементов групп i-iii-vi
Формула / Реферат
1. Четырех- и более компонентный полупроводниковый сплав из элементов группы IB-IIIA-VIA, имеющий общую формулу (I)

в которой А означает элемент группы IB;
В означает элемент группы IIIA;
С означает элемент группы IIIА, который отличается от В;
D является первым элементом группы VIA (в последующем называется как VI1);
Е является вторым элементом группы VIA (в последующем называется как VI2); и
каждый из х и у независимо имеют значения от 0 до 1, при условии, что х и у не равны 0 одновременно,
причем сплав отличается тем, что на дифрактограмме рентгеновских лучей (XRD) имеется основной [112] пик со значением угла 2q (2q[112]) от 26 до 28ш для медного излучения при 40 кВ, при этом на дифрактограмме рентгеновской спектроскопии под малым углом измерения (GIXRD) при значении скользящего угла от 0,2 до 10ш наблюдается абсолютное смещение угла 2q[112] меньше чем на 0,06ш.
2. Сплав по п.1, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,01 Е.
3. Сплав по п.1, в котором концентрация элементов А, В, С, D и Е сплава, характеризуемая по глубине профиля в рентгеновском фотоэлектронном спектре (XPS), является, по существу, однородной по всему сплаву.
4. Сплав по п.1, в котором А означает Cu, В означает In, С означает Ga, D означает Se и Е означает S, причем сплав имеет формулу (II)

5. Сплав по п.4, в котором х имеет значение от 0,25 до 0,3 и у от 0,05 до 0,8.
6. Сплав по п.4, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной [112] пик при значении угла 2q (2q[112]) от 26,9 до 28ш для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3117 до 3,1840 Е.
7. Сплав по п.4, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10ш наблюдается абсолютное смещение значения угла 2q[112] меньше чем на 0,01ш.
8. Сплав по п.4, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,001 Е.
9. Сплав по п.6, в котором основной [112] пик находится при значении угла 2q от 27,0 до 27,5ш.
10. Сплав по п.6, в котором основной [112] пик является, в основном, симметричным.
11. Сплав по п.4, в котором ширина запрещенной зоны может изменяться от 1 до 2,4 эВ.
12. Сплав по п.11, в котором ширина запрещенной зоны может изменяться от 1,1 до 1,5 эВ.
13. Сплав по п.4, в котором содержание серы, выраженное атомным отношением S/(Se+S), лежит в пределах от 0,05 до 0,7.
14. Сплав по п.1, в котором А означает Cu, В представляет собой In, С означает Ga, D означает Se и у=0, причем сплав имеет общую формулу (III)
![]()
15. Сплав по п.14, в котором х изменяется от 0,25 до 0,3.
16. Сплав по п.14, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,006 Е.
17. Сплав по п.14, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной [112] пик при значении угла 2q (2q[112]) от 26,8 до 27ш для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3236 до 3,2990 Е.
18. Сплав по п.14, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10ш наблюдается абсолютное смещение значения угла 2q[112] меньше чем на 0,05ш.
19. Сплав по п.17, в котором основной [112] пик находится при значении угла 2q от 26,85 до 26,9ш.
20. Сплав по п.17, в котором основной [112] пик является, в основном, симметричным.
21. Сплав по п.14, в котором ширина запрещенной зоны может изменяться от 1,1 до 1,2 эВ.
22. Сплав по п.21, в котором ширина запрещенной зоны может изменяться от 1,15 до 1,18 эВ.
23. Сплав по п.14, в котором содержание галлия, выраженное атомным отношением Ga/(Ga+In), лежит в пределах от 0,25 до 0,3.
24. Сплав по п.1, в котором А означает Cu, В означает In, D означает Se и х=0, причем сплав имеет общую формулу (IV)

25. Сплав по п.24, в котором у изменяется от 0,1 до 0,5.
26. Сплав по п.24, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,007 Е.
27. Сплав по п.24, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной [112] пик при значении угла 2q (2q[112]) от 26,80 до 27,3ш для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3236 до 3,2640 Е.
28. Сплав по п.24, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10ш наблюдается абсолютное смещение значения угла 2q[112] меньше чем на 0,06ш.
29. Сплав по п.27, в котором основной [112] пик находится при значении угла 2q от 27,0 до 27,2ш.
30. Сплав по п.24, в котором ширина запрещенной зоны может изменяться от 1,05 до 1,23 эВ.
31. Сплав по п.30, в котором ширина запрещенной зоны может изменяться от 1,15 до 1,20 эВ.
32. Сплав по п.24, в котором содержание серы, выраженное атомным отношением S/(Se+S), лежит в пределах от 0,1 до 0,5.
33. Полупроводниковая пленка, которая включает в себя сплав по п.1.
34. Полупроводниковая пленка по п.33, содержащая подложку, на которую осажден сплав по п.1.
35. Полупроводниковая пленка по п.33, в которой сплав находится в виде слоя, имеющего толщину от 1,5 до 2,0 мкм.
36. Фотоэлектрический преобразователь, включающий полупроводниковую пленку из сплава по п.1.
37. Фотоэлектрический преобразователь по п.36, который имеет эффективность преобразования от 8 до 15%.
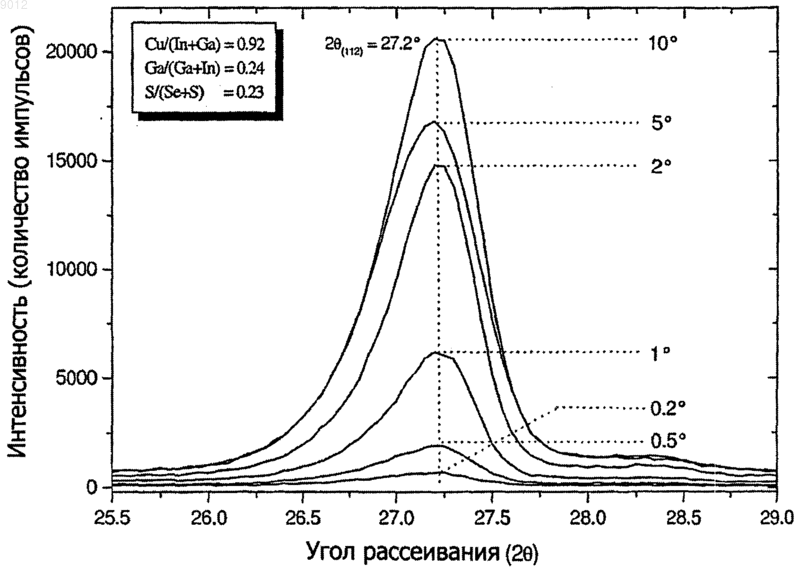
Текст
009012 Область техники, к которой относится изобретение Это изобретение относится к полупроводниковым пленкам из четырех- и более компонентных сплавов элементов групп I-III-VI. Более конкретно, но не исключительно, это изобретение относится к четырем и более компонентным сплавам элементов групп I-III-VI, которые являются большей частью гомогенными. Кроме того, изобретение относится, по существу, к гомогенным полупроводниковым пленкам из четырех- и более компонентных сплавов элементов групп I-III-VI, которые подходят для применения в качестве полупроводниковых пленок в фотоэлектрических/солнечных преобразователях. Уровень техники Определения. В рамках этого описания термин "пятеричный сплав" относится к сплаву, имеющему пять различных элементов. Так, например, Cu(In,Ga)(S,Se)2 представляет собой пятеричный сплав из элементов групп IB-IIIА-VIА, в котором пятью различными элементами являются медь (Cu), индий (In), галлий(Ga), селен (Se) и сера (S). Аналогично, термин "четверной сплав" относится к сплаву, имеющему 4 различных элемента. Так, например, Cu(In,Ga)Se2 представляет собой четверной сплав из элементов группIB-IIIA-VIA. Подобным образом, тройной сплав имеет три различных элемента, и бинарный сплав имеет два различных элемента. Термин "гомогенный" сплав означает, что различные элементы, составляющие сплав, распределены равномерно по всему сплаву, так что сплав имеет, по существу, постоянный параметр решетки, межплоскостное расстояние (в последующем называется d-параметр) и ширину запрещенной зоны по всему сплаву. Другими словами, абсолютное смещение основного дифракционного пика для сплава [2(112)],характеризующегося дифракцией скользящих падающих рентгеновских лучей для скользящих углов между 0,5 и 10, является незначительным. Более того, в рамках этого описания "гетерогенный" сплав означает, что сплав имеет переменную структуру запрещенной зоны и претерпевает постепенное изменение состава таким образом, что изменяется атомная концентрация одного или нескольких элементов, входящих в состав сплава. Кроме того,гетерогенный сплав может включать рассогласования параметров решетки кристаллической структуры и соответственно может претерпевать изменения параметров решетки кристаллической структуры всего сплава. Из соображений удобства элементы обозначаются с использованием обычно принятых химических символов, включающих медь (Cu), индий (In), галлий (Ga), селен (Se), серу (S), аргон (Ar), молибден(Мо) и алюминий (Al). Кроме того, использование дефиса (например, в Cu-In-Ga или Cu-In) не обязательно указывает на соединение, но указывает на совместно существующую смесь элементов, соединенных дефисом. С целью ясности ссылка на группу IB относится к группе в периодической таблице, содержащей элементы Cu, Ag и Au. Ссылка на группу IIIА относится к группе в периодической таблице, содержащей элементы В, Al, Ga, In и Тl. Кроме того, ссылка на группу VIA относится к группе в периодической таблице, содержащей элементы О, S, Se, Те и Ро. Запятая между двумя элементами, например (Se,S), (In, Ga), используется просто с целью удобства и, таким образом, например, (Se,S) представляет собой краткую запись (Se1-ySy). Полупроводниковый пленочный материал. В настоящее время кристаллический и поликристаллический кремний является основным материалом, используемым в производстве солнечных модулей/фотоэлектрических преобразователей. Основной проблемой, связанной с этим материалом, является высокая стоимость их производства. С целью снижения стоимости производства и увеличения степени использования материала, тонкие пленки из полупроводниковых сплавов были предметом интенсивных исследований. В связи с этим, сплавы из элементов групп IB-IIIA-VIA, таких как CuInSe2, CuGaSe2 и CuInS2, оказались многообещающими кандидатами для поглощающих слоев в тонкопленочных фотоэлектрических преобразователях или устройствах. Особый интерес вызывают полупроводниковые пленки, содержащие сплав из элементов групп IBIIIA-VIA, в которых сплав включает Ga в сочетании с другими элементами группы III, так как наличиеGa в таких пленках приводит к полупроводниковым пленкам с более широкой запрещенной зоной и,следовательно, к солнечным/фотоэлектрическим преобразующим устройствам, с более высоким значением фотоэдс и с меньшим током короткого замыкания. Еще больший интерес вызывают полупроводниковые пленки, содержащие пятеричные сплавы (полупроводниковые пленки из пятеричных сплавов). Что касается полупроводниковых пленок, содержащих пятеричные сплавы, имеющие общую формулу Cu(In1-xGax)(Se1-ySy)2, то ширина запрещенной зоны может быть сдвинута в область между 1,0 и 2,4 эВ для того, чтобы добиться оптимального соответствия с солнечным спектром. Оптимизация этой системы уже позволила создать лабораторные солнечные элементы с эффективностью преобразования, превышающей 18%. Способы уровня техники. Существует рад способов получения полупроводниковых пленок из элементов групп IB-IIIA-VIA,-1 009012 причем двумя наиболее распространенными способами являются традиционный двухстадийный процесс и способ совместного напыления. Традиционный двухстадийный процесс. Обычно указанный выше процесс включает (i) осаждение металлических предшественников, таких как Cu, In и Ga, на подложку, которая чаще всего покрыта молибденом, с помощью магнетронного распыления при постоянном токе, с последующим (ii) реакционным отжигом этих предшественников в атмосфере, содержащей пары Se, и/или S, или газов H2Se/Ar, и/или H2S/Ar. Эти методики раскрыты в статьях V. Alberts, J.H. Schon, и Е. Bucher, Journal of Appl. Phys. 84(12), 1998, 6881 и А. Gupta и S. Isomura, Sol. Energy Mater. Sol. Cells, 53,1998, 385.He желая ограничивать себя теорией и ссылаясь на статью J. Palm, V. Probst, W. Stetter и др., ThinSolid Films, 451-452 (2004) 544-551, авторы предполагают, что при селенизации металлических предшественников Cu-In-Ga образуются бинарные сплавы, такие как CuSe и In4Se3, Cu2-xSe и InSe. Последующая реакция между этими фазами бинарных предшественников при температуре выше 370 С приводит к образованию тройного сплава CuInSe2 (CIS). Считают, что в ходе селенизации образуется только последний сплав, причем селенизация галлия кинетически затруднена, так что в ходе образования CIS галлий направляется к молибденовой подложке. Кроме того, считают, что при дополнительном отжиге образуется отдельный слой Cu(In,Ga)Se2 (CIGS) таким образом, что образуется структура двойного слоя, включающая хорошо кристаллизованный CIS слой сверху обогащенного галлием мелкокристаллического слоя CIGS в контакте с задним электродом. Длительный отжиг, который нежелателен для промышленности, приводит к диффузии Ga от заднего электрода к поверхности структуры. Эффект сегрегированной или ступенчатой структуры пленки, с наибольшей частью галлия, оставшейся сзади пленки, заключается в том, что поглощающая пленка обладает малой шириной запрещенной зоны в активной области фотоэлектрического преобразователя, что в конечном счете ограничивает величину VOC устройства. Величины фотоэдс (VOC) и тока короткого замыкания (Jsc) для солнечных модулей/фотоэлектрических преобразователей непосредственно связаны с шириной запрещенной зоны полупроводникового материала. В случае CuInSe2 с малой шириной запрещенной зоны около 1 эВ, обычно значения VOC ограничиваются величиной 500 мВ, в то время как, используя поглощающий слой изCuGaSe2 с большей шириной запрещенной зоны (1,65 эВ), могут быть получены значения, близкие к 1000 мВ. Кроме того, в случае сильного сегрегирования, рассогласование параметров решетки внутри сегрегированных поглощающих пленок приводит к появлению электрически активных структурных дефектов,которые отрицательно воздействуют на параметры работы устройства. С целью устранения недостатков гетерогенного Cu(In,Ga)Se2 сплава с малой шириной запрещенной зоны, полученного с помощью традиционного двухстадийного процесса, пленки обычно обрабатывают сероводородом (H2S). Существующие промышленные способы включают стадию последующего сульфидирования, на которой определенная фракция селеновых частиц в верхней области поверхности пленки заменяется на серу (K. Kushiya, M. Tachiyuki, Т. Kase, I. Sugiyama, Y. Nagoya, D. Okurnura, M. Satoh, O. Yamase, и H.and Solar Cells. 49,1997, 285). В конечном счете, этот подход приводит к формированию тонкого поверхностного слояCu(In,Ga)(Se,S)2 на образовавшейся ступенчатой Cu(In1-xGax)Se2 структуре. Этот поверхностный слой имеет резкое сегрегирование, причем его глубина в структуре Cu(In,Ga)Se2 имеет порядок величины 50 нм. Указанная выше стадия последующего сульфидирования, которая уже применяется в промышленном масштабе, имеет следующие недостатки:(i) низкая скорость обмена между частицами селена и серы в этих пленках,(ii) достигается только незначительное увеличение значения фотоэдс в солнечных элементах,(iii) для достижения значительной степени внедрения серы требуются условия высокой температуры и длительного времени взаимодействия, между 90 и 120 мин, что, в конечном счете, повышает затраты производственного процесса; и(iv) образующиеся сплавы являются гетерогенными, что делает невозможным эффективный контроль значений параметров решетки и ширины запрещенной зоны. Кроме того, в статье М. Marudachalam, H. Hichri, R. Klenk, R.W. Birkmire, W.N. Schfarman и J.M.Schultz, Appl. Phys. Lett. 67(26), 1995, 3978, было продемонстрировано, что тонкие пленки Cu(In,Ga)Se2 с улучшенной однородностью могут быть получены с помощью локального отжига смеси отдельных фазCuInSe2 и CuGaSe2 в аргоне, в диапазоне температур от 500 до 600 С, в течение от 60 до 120 мин. Однако при исследовании глубины профиля этих конкретных сплавов методом Оже-спектрометрии были выявлены значительные изменения концентраций In и Ga по глубине, что указывает на неоднородности сплавов.-2 009012 Кроме того, осуществление стадии последующего отжига в инертной атмосфере приводит к значительным потерям Se из пленки, поэтому требуется вторая стадия отжига в атмосфере H2Se/Ar. Дополнительные стадии последующего отжига в инертной атмосфере, а также в среде H2Se/Ar, не только приводит к нарушению воспроизводимости процесса, но также делают нереальной его промышленную реализацию. Одностадийные способы. В другой попытке получения гомогенных пятеричных сплавов был разработан комплексный одностадийный способ. В этом способе, описанном в работе I.M. Ktschau, Н. Kerber, H. Wiesner, G. Hanna иH.W. Schock, Proceedings of the 16th European Photovoltaic Solar Energy Conference, 1-5 May 2000,Glasgow, UK, с 724-727, все элементы (Cu, In, Ga, Se и S) совместно испаряются в глубоком вакууме, в постоянном потоке из отдельных источников. Этот способ обеспечивает контролируемое внедрение галлия и серы внутрь пленок, что приводит к уменьшению параметров решетки сплавов. Последующее увеличение ширины запрещенной зоны для пятеричных сплавов, в конечном счете, приводит к увеличению значений фотоэдс для готовых солнечных элементов. Однако рентгеновская спектроскопия под малым углом измерения (GIXRD) при малых углах падения между 0,4 и 5 выявила значительное изменение параметров решетки между поверхностью и объемом материала. Авторы объясняют это явление обеднением приповерхностного слоя медью,которое подтверждает тот факт, что эти сплавы являются скорее композиционно сегрегированными, чем гомогенными. В настоящем изобретении неожиданно было установлено, что рассмотренные выше значительные проблемы могут быть, по меньшей мере, частично устранены или ослаблены путем регулирования образования тройных сплавов на стадии селенизации таким образом, что реакция селенизации не протекает до конца с образованием полностью прореагировавших тройных сплавов без образования бинарных сплавов. Раскрытие изобретения Целью этого изобретения является разработка новых четверных и пятеричных сплавов. Дополнительной целью этого изобретения является разработка новых, по существу, гомогенных четверных и пятеричных сплавов, подходящих для применения в качестве полупроводниковых пленок,за счет применения таких сплавов, по меньшей мере, частично минимизируются недостатки, связанные с полупроводниковыми пленками, содержащими гетерогенные сплавы. Краткое изложение существа изобретения В настоящем изобретении предложен четырех- или более компонентный сплав из элементов группы IB-IIIA-VIA, имеющий общую формулу (I) в которой А означает элемент группы IB; В означает элемент группы IIIА; С означает элемент группы IIIА, который отличается от В;D является первым элементом группы VIA (в последующем называется как VI1); Е является вторым элементом группы VIA (в последующем называется как VI2); и каждый из х и у независимо может изменяться от 0 до 1, при условии, что х и у не равны 0 одновременно,причем сплав отличается тем, что в дифрактограмме рентгеновских лучей (XRD) имеется основной [112] пик со значением угла 2 (2[112]) от 26 до 28 для медного излучения (Cu) при 40 кВ, при этом в дифрактограмме рентгеновской спектроскопии под малым углом измерения (GIXRD) при значении скользящего угла от 0,2 до 10 наблюдается абсолютное смещение значения угла 2[112] меньше чем на 0,06. Предпочтительно сплав имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения dпараметра меньше чем на 0,01 . В предпочтительном варианте воплощения изобретения концентрация элементов А, В, С, D и Е сплава, характеризуемая по глубине профиля в рентгеновском фотоэлектронном спектре (XPS), является,по существу, однородной по всему сплаву. Пятеричные сплавы В одном варианте воплощения изобретения А означает Cu, В означает In или Al, предпочтительноIn, С означает Ga, D означает Se и Е означает S. Как х, так и у больше 0. Предпочтительно пятеричный сплав имеет формулу (II) В предпочтительном варианте воплощения изобретения х может изменяться от 0,25 до 0,3 и у может изменяться от 0,05 до 0,8. Сплав формулы (II) предпочтительно имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,001 . Предпочтительно абсолютное изменение значения угла 2[112]-3 009012 составляет меньше чем 0,01. Предпочтительно концентрация Cu, In, Ga, Se и S является постоянной по всей глубине сплава, которая характеризуется определением глубины профиля методом XPS. В предпочтительном варианте воплощения изобретения сплав формулы (II) может характеризоваться с помощью дифрактограммы рентгеновских лучей (XRD), имеющей основной [112] пик при значении угла 2 (2[112]) от 26,9 до 28 для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3117 до 3,1840 . Предпочтительно пик 2[112] является, в основном, симметричным. В предпочтительном варианте воплощения изобретения пик 2[112] может находиться в диапазоне от 27,0 до 27,5. Сплав формулы (II) может быть дополнительно охарактеризован тем, что ширина запрещенной зоны сплава может непрерывно изменяться от 1 до 2,4 эВ, предпочтительно от 1,1 до 1,5 эВ. В предпочтительном варианте воплощения изобретения атомное отношение серы (S) к сумме(Se+S), т.е. содержание серы, выраженное отношением S/(Se+S), лежит в пределах от 0,05 до 0,7. В предпочтительном варианте воплощения изобретения сплав формулы (II) является гомогенным. Четверные сплавыCu(In, Ga)Se2. В другом варианте воплощения изобретения А означает Cu, В означает In, С означает Ga, D означает Se и у=0,Предпочтительно четверной сплав имеет формулу (III) В предпочтительном варианте воплощения изобретения х может изменяться от 0,25 до 0,3. Предпочтительно сплав формулы (III) имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,006 . Предпочтительно абсолютное изменение значения угла 2[112] составляет меньше чем 0,05. Предпочтительно концентрация Cu, In, Ga и Se является постоянной по всей глубине сплава, которая характеризуется определением глубины профиля методом XPS. В предпочтительном варианте воплощения изобретения сплав формулы (III) может характеризоваться с помощью дифрактограммы рентгеновских лучей (XRD), имеющей основной [112] пик при значении угла 2 (2[112]) от 26,8 до 27 для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3236 до 3,2990 . Предпочтительно 2[112] пик является, по существу, симметричным. В предпочтительном варианте воплощения изобретения пик 2[112] может находиться в области от 26,85 до 26,9. Кроме того, сплав формулы (III) может характеризоваться тем, что ширина его запрещенной зоны может изменяться от 1,1 до 1,2 эВ, предпочтительно от 1,15 до 1,18 эВ. В предпочтительном варианте воплощения изобретения атомное отношение Ga к сумме Ga+In, т.е. содержание галлия, выраженное отношением Ga/(Ga+In), лежит в пределах от 0,25 до 0,3. В предпочтительном варианте воплощения изобретения сплав формулы (III) является, в основном,гомогенным.CuIn(Se,S)2. Согласно еще одному варианту воплощения изобретения А означает Cu, В означает In, D означаетSe, Е означает S и х=0. Предпочтительно четверной сплав имеет формулу (IV) В предпочтительном варианте воплощения изобретения у может изменяться от 0,1 до 0,5. Сплав формулы (IV) предпочтительно имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,007 . Предпочтительно значение угла 2[112] изменяется меньше чем на 0,06. Предпочтительно концентрация Cu, In, Se и S является постоянной по всей глубине сплава, которая характеризуется определением глубины профиля методом XPS. В предпочтительном варианте воплощения изобретения сплав формулы (IV) может характеризоваться с помощью дифрактограммы рентгеновских лучей (XRD), имеющей основной [112] пик при значении угла 2 (2[112]) от 26,80 до 27,3 для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3236 до 3,2640 . Предпочтительно пик 2[112] является, по существу, симметричным. В предпочтительном варианте воплощения изобретения пик 2[112] может находиться в диапазоне от 27,0 до 27,2. Кроме того, сплав формулы (IV) может характеризоваться тем, что ширина запрещенной зоны может изменяться от 1,05 до 1,23 эВ, предпочтительно от 1,15 до 1,20 эВ. В предпочтительном варианте воплощения изобретения атомное отношение серы к сумме (S+Se),т.е. содержание серы, выраженное отношением S/(Se+S), лежит в пределах от 0,1 до 0,5. В предпочтительном варианте воплощения изобретения сплав формулы (IV) является, в основном,-4 009012 гомогенным. Другим замыслом изобретения является полупроводниковая пленка, включающая сплав формулы(I). Предпочтительно эта полупроводниковая пленка включает носитель для сплава формулы (I), предпочтительно подложку. В предпочтительном варианте воплощения изобретения эта подложка может включать в себя металлический слой. Этот металлический слой предпочтительно может быть слоем молибдена (Мо). Полупроводниковая пленка, содержащая сплав формулы (I), может иметь толщину от 1,5 до 2,0 мкм. Согласно другому замыслу изобретения предусмотрен фотоэлектрический/солнечный преобразователь, включающий полупроводниковую пленку, содержащую сплав формулы (I). В предпочтительном варианте воплощения изобретения фотоэлектрический/солнечный преобразователь имеет эффективность преобразования от 8 до 15%. Согласно еще одному замыслу изобретения предусмотрен способ получения полупроводниковой пленки из четырех- или более компонентного сплава из элементов групп IB-IIIA-VIA, причем этот способ включает в себя стадии:i. предоставления металлической пленки, содержащей смесь металлов из группы IB и группы IIIA;ii. термической обработки металлической пленки в присутствии источника первого элемента группы VIA (в последующем этот первый элемент группы VIA называется как VIA1) в условиях формирования первой пленки, содержащей смесь по меньшей мере одного бинарного сплава, который выбирают из группы, состоящей из сплава элементов групп IB-VIA1 и сплава элементов групп IIIA-VIA1 и по меньшей мере одного тройного сплава элементов из групп IB-IIIA-VIA1;iii. необязательной термической обработки первой пленки в присутствии источника второго элемента из группы VIA (указанный второй элемент из группы VI в последующем называется как VIА 2) в таких условиях, чтобы превратить первую пленку во вторую пленку, которая включает в себя по меньшей мере один сплав, выбранный из группы, состоящей из сплава элементов групп IB-VIA1-VIA2 и сплава элементов групп IIIA-VIA1-VIА 2; и по меньшей мере одного тройного сплава элементов из групп IBIII-VIA1 со стадии (ii);iv. термической обработки или первой пленки, или второй пленки для того, чтобы образовалась полупроводниковая пленка из четырех- или более компонентного сплава элементов из групп IB-IIIA-VIA,причем VIA может представлять собой VIA1 и/или VIA2. Предпочтительно смесь первой пленки представляет собой стабильную смесь, в которой молярное отношение всех элементов групп IB-VIA1 и/или групп IIIA-VIA1 в сплавах по меньшей мере к одному элементу из групп IB-IIIA-VIA1 в тройном сплаве остается, в основном, постоянным. Стадия (i). Металлическая пленка стадии (i) может быть представлена на подложке, причем эта подложка предпочтительно является инертной в условиях стадий реакции и термической обработки указанного выше способа. Подходящие подожки включают стекло, гибкую металлическую или полимерную фольгу или тому подобное. Предпочтительно подложка имеет толщину от 0,05 до 3,0 мм. Подложка необязательно может быть покрыта металлическим слоем, предпочтительно слоем молибдена, имеющим толщину от 0,5 до 1,0 мкм. Предпочтительно металлическая пленка наносится на металлический слой. Этот металлический слой также может выполнять функцию электрического контактного слоя в фотоэлектрическом преобразователе. Металлическая пленка стадии (i) включает смесь металлов, и в одном варианте воплощения предпочтительно содержит по меньшей мере два различных металла группы IIIА. В предпочтительном варианте воплощения изобретения металлическая пленка стадии (i) включает в себя смесь металлов, которые выбирают из группы, состоящей из Cu, In и Ga, предпочтительно сочетания Cu, In и Ga, причем эти металлы могут находиться в виде элементов или в виде сплава. Предпочтительно источником Cu и Ga является сплав, предпочтительно сплав Cu0,75Ga0,25. Предпочтительно металлической пленкой является Cu-In-Ga сплав. Другими элементами группы III, представляющими интерес при добавлении к галлию, являются Al и Тl. В другом варианте воплощения изобретения металлическая пленка стадии (i) включает в себя смесь только Cu и In, без добавления Ga. Предпочтительной металлической пленкой является Cu-In сплав. В предпочтительном варианте воплощения изобретения общее количество элементов группы IIIA,осажденных на подложку, может быть достаточным для обеспечения молярного отношения элементов из группы IB к группе IIIA, например Cu/(In+Ga), которое изменяется от 0,7 до 1,0, предпочтительно от 0,8 до 1,0 и более предпочтительно от 0,90 до 0,95. Металлы могут быть осаждены на подложку с помощью способов, которые хорошо известны из уровня техники, таких как магнетронное распыление на постоянном токе, для того чтобы образовалась металлическая пленка, которая может иметь толщину от 0,6 до 1 мкм, предпочтительно 0,6 мкм. Следует принять во внимание, что существуют другие средства, с помощью которых металлы группы IB и группы IIIА или их сплавы могут быть осаждены на подложку, такие как, например, электрическое осаждение или электронно-лучевое напыление.-5 009012 Стадия (ii). Металлическую пленку стадии (i) подвергают термической обработке в присутствии источника элемента группы VIA1. Предпочтительным элементом группы VIA1 является Se. Более предпочтительно источник содержит газообразную смесь H2Se и предпочтительно по меньшей мере один другой газ,предпочтительно инертный газ, такой как Ar. Кроме того, предусматривается, что также может быть использован элементарный селен в виде паров. Молярная концентрация селена относительно по меньшей мере одного другого газа, предпочтительно Ar, может составлять от 0,01 до 15 мол.%, предпочтительно от 0,1 до 1,0 мол.% и наиболее предпочтительно концентрация Se относительно по меньшей мере одного другого газа составляет 0,12%. В одном варианте воплощения изобретения стадию (ii) проводят в условиях реакции, когда реакционная температура составляет от 300 до 500 С, предпочтительно от 350 до 450 С. В предпочтительном варианте воплощения изобретения металлическую пленку стадии (i) нагревают до реакционной температуры, указанной выше, в течение 5-30 мин, предпочтительно от 10 до 20 мин. Предпочтительно металлическую пленку стадии (i) подвергают воздействию источника элемента группы VIA1 в течение периода от 10 до 120 мин, предпочтительно от 15 до 90 мин и более предпочтительно между 30 и 60 мин. На стадии (ii) поддерживают давление между 104 и 105 Па, предпочтительно от 5104 до 9104 Па. В одном варианте воплощения изобретения металлическую пленку стадии (i) подвергают термической обработке в присутствии источника Se, чтобы получить первую пленку, которая включает в себя стабильную смесь бинарных сплавов, содержащих CuSe, InSe и Ga2Se3 и по меньшей мере один тройной сплав элементов из групп IB-IIIA-VIA. Предпочтительно первая пленка стадии (ii) имеет менее 50 атомных процентов элемента из группыVIA1. Более предпочтительно первая пленка имеет дефицит селена, поскольку первая пленка содержит менее 50 атомных процентов Se. Предпочтительно первая пленка имеет концентрацию Se от 43 до 47 атомных процентов, относительно 50 атомных процентов, необходимых для стехиометрически полностью прореагировавших пленок. Предпочтительно отношение Se/(Cu+Ga+In) составляет менее 1. В предпочтительном варианте воплощения указанного выше способа, и после проведения стадии(ii) согласно изобретению, первая пленка может быть подвергнута обработке в таких условиях, чтобы обеспечить сохранение стабильной смеси бинарных сплавов и по меньшей мере одного тройного сплава элементов из групп IB-IIIA-VIA. Предпочтительно эти условия включают удаление источника элемента группы VIA1, и тем самым сохраняется стабильность смеси. В предпочтительном варианте воплощения эти условия также могут включать обработку первой пленки в инертной атмосфере, предпочтительно в аргоне, в течение периода от 5 до 20 мин, предпочтительно от 10 до 15 мин. Кроме того, первая пленка может быть охлаждена,предпочтительно до температуры ниже 200 С. Способ формирования полупроводниковой пленки из пятеричного сплава элементов из групп IB-IIIA-VIA Стадии (i) и (ii). Стадии (i) и (ii) являются такими, как изложено выше. Более конкретно стадия (i) включает в себя предоставление металлической пленки, содержащей смесь по меньшей мере одного элемента группы IB,элемента группы IIIА (первый элемент из группы IIIА в последующем называется как IIIA1) и второго элемента группы IIIА (второй элемент из группы IIIА в последующем называется как IIIAr). Стадия (ii) включает в себя термическую обработку металлической пленки со стадии (i) в присутствии источника элемента VIA1 в условиях, когда образуется первая пленка, содержащая смесь бинарных сплавов, которые выбирают из группы, содержащей сплав групп IB-VIA1, сплав элементов из групп IIIA1-VIA1 и сплав элементов из групп IIIA2-VLA1, и двух тройных сплавов, а именно, сплав элементов из групп IB-IIIA1VIA1 и сплав элементов из групп IB-IIIA2-VIA1. Стадия (iii). В одном варианте воплощения изобретения первую пленку со стадии (ii) подвергают термической обработке в присутствии источника второго элемента из группы VIA2, предпочтительно для того, чтобы превратить первую пленку во вторую пленку, содержащую по меньшей мере один сплав, который выбирают из группы, состоящей из сплава элементов из групп IB-VIA1-VIA2 и сплава элементов из группIIIA-VIA1-VIA2, предпочтительно из сплава элементов из групп IIIA1-VIA1-VIA2 и сплава элементов из групп IIIA2-VIA1-VIA2; и по меньшей мере одного тройного сплава элементов из групп IB-IIIА-VIA1 со стадии (ii). Предпочтительно группа VIA2 представляет собой источник серы. В предпочтительном варианте воплощения изобретения источник серы включает в себя газообразную смесь H2S и по меньшей мере одного инертного газа, предпочтительно такого инертного газа, как Ar. В предпочтительном варианте воплощения изобретения молярная концентрация серы относительно по меньшей мере одного инертного газа, предпочтительно Ar, может составлять от 0,1 до 10 мол.%,предпочтительно от 0,3 до 0,5 мол.%, наиболее предпочтительно концентрация серы относительно по-6 009012 меньшей мере одного другого газа составляет 0,35%. Стадия (iii) термической обработки может быть проведена при температуре от 100 до 500 С, предпочтительно от 400 до 500 С, более предпочтительно 450 С, в течение периода от 5 до 10 мин, предпочтительно 5 мин. В предпочтительном варианте воплощения изобретения элемент группы IB представляет собой Cu,элементом группы IIIA1 является In, элемент группы IIIA2 представляет собой Ga, элементами группVIA1 и VIA2 являются Se и S. Предпочтительно вторая пленка содержит смесь сплавов, выбранных из группы, состоящей изCu(Se,S), In(Se,S) и Ga(Se,S), предпочтительно все эти три, и тройные сплавы, а именно CuGaSe2 и CuInSe2, предпочтительно оба этих сплава. Стадия (iv). В предпочтительном варианте воплощения изобретения вторая пленка со стадии (iii) может быть отожжена, предпочтительно в присутствии источника серы, в течение периода от 5 до 10 мин, предпочтительно 5 мин, при температуре от 450 до 600 С, предпочтительно от 500 до 550 С, более предпочтительно 500 С, так что по меньшей мере один из сплавов, выбранных из группы, состоящей из сплава элементов из групп IB-VIA1-VIA2, групп IIIA1-VIA1-VIA2 и групп IIIA2-VI1-VI2, взаимодействует по меньшей мере с одним тройным сплавом из групп IB-IIIA-VIA1 со стадии (ii), чтобы получить третью пленку, содержащую смесь четверных сплавов элементов из групп IB-IIIA-VIA, содержащих или два металла из группы IIIA, или два элемента из группы VIA, а именно VIA1 и VIA2. Более предпочтительно третья пленка содержит смесь четверных сплавов, которые выбирают из группы, состоящей из сплава элементов из групп IB-IIIA1-VIA1-VIA2 и сплава элементов из групп IBIIIA2-VIA1-VIA2. Более предпочтительно третья пленка содержит смесь CuIn(Se,S)2 и CuGa(Se,S)2. Четверные сплавы CuIn(Se,S)2 и CuGa(Se,S)2 предпочтительно являются, в основном, гомогенными. Предпочтительно третью пленку отжигают в течение 15-90 мин, более предпочтительно 30 мин при температуре от 500 до 600 С, предпочтительно от 520 до 580 С, более предпочтительно при 550 С, чтобы получить пятеричный сплав, имеющий общую формулу II в которой предпочтительно х может изменяться от 0,1 до 0,5, предпочтительно от 0,25 до 0,3 и у может предпочтительно изменяться от 0 до 1, более предпочтительно от 0,05 до 0,7. Предпочтительно пятеричный сплав является гомогенным и предпочтительно может быть отожжен в течение дополнительного периода времени, предпочтительно 15 мин, чтобы оптимизировать структурные свойства сплава. Гомогенная пленка может иметь толщину от 1,5 до 2,0 мкм. Способ получения полупроводниковой пленки из четверного сплава элементов из групп IB-IIIA-VIA Полупроводниковые пленки из четверного сплава Cu(In,Ga)Se2. Стадия (i) и стадия (ii). Стадии (i) и (ii) являются такими же, как изложено выше. Более конкретно, стадия (i) включает в себя предоставление металлической пленки, включающей смесь по меньшей мере одного элемента из группы IB, элемента группы IIIA1 и элемента группы IIIА 2. Стадия (ii) включает в себя термическую обработку металлической пленки со стадии (i) в присутствии источника элемента VIA1 в условиях, в которых образуется первая пленка, содержащая смесь бинарных сплавов, выбранных из группы, состоящей из сплава элементов из групп IB-VIA1, сплава элементов из групп IIIA1-VIA1 и сплава элементов из группIIIA2-VIA1, причем тройной сплав представляет собой сплав элементов из групп IB-IIIA1-VIA1. В предпочтительном варианте воплощения изобретения стадию (ii) проводят при температуре от 350 до 450 С, предпочтительно при 400 С, так что первая пленка включает в себя стабильную смесь бинарных сплавов, выбранных из группы, состоящей CuSe, InSe и Ga2Se3, где элемент IB означает Cu, IIIA1 означает In, IIIA2 означает Ga и VIA1 означает Se; и единственный тройной сплав, а именно CuInSe2,Предпочтительно чтобы образование CuGaSe2 было затруднено. Стадия (iv). В одном варианте воплощения изобретения первую пленку стадии (ii) подвергают первой стадии термической обработки и второй стадии термической обработки для того, чтобы образовался сплав элементов из групп IB-IIIA1-IIIA2-VIA1. В предпочтительном варианте воплощения изобретения первый этап термической обработки на стадии (iv) включает в себя нагревание первой пленки со стадии (ii) до реакционной температуры от 100 до 600 С в присутствии инертного газа, предпочтительно в атмосфере, содержащей аргон. Предпочтительно первую пленку со стадии (ii) нагревают до реакционной температуры в течение 5 мин. Второй этап термической обработки стадии (iv) включает в себя первый отжиг первой пленки в присутствии инертной атмосферы, предпочтительно в присутствии Ar. Предпочтительно первую пленку со стадии (ii) сначала отжигают в присутствии аргонсодержащей атмосферы, предпочтительно при температуре от 100 до 600 С, предпочтительно от 200 до 550 С, более предпочтительно от 500 до 550 С, в течение 10-60 мин, предпочтительно от 15 до 30 мин, и затем отжигают вторично в присутствии источника элемента VIA1.-7 009012 Предпочтительно элемент VIA1 представляет собой Se, как на стадии (ii). Первую пленку со стадии(ii) отжигают в присутствии источника Se, предпочтительно в течение 10-60 мин, более предпочтительно 30 мин, при температуре от 100 до 600 С, предпочтительно от 200 до 550 С, более предпочтительно при 500 С, чтобы образовался четверной сплав формулы (III), в которой элемент IB представляет собой Cu,IIIA1 означает In, IIIA2 означает Ga и VIA1 означает Se и в которой х может изменяться от 0,25 до 0,30. Предпочтительно источником селена является атмосфера H2Se и по меньшей мере один другой газ,предпочтительно инертный газ, такой как Ar. Предпочтительно молярная концентрация селена относительно по меньшей мере одного другого газа составляет 0,12%. В предпочтительном варианте воплощения изобретения первую пленку (ii) подвергают обработке на следующих последовательных стадиях:(а) нагревание первой пленки в реакционной трубке в инертной атмосфере Ar до реакционной температуры 500 С в течение 5 мин;(b) отжиг первой пленки в реакционной трубке в аргонсодержащей атмосфере при 500 С по меньшей мере в течение 15 мин;(c) отжиг первой пленки при 500 С в присутствии 0,12 мол.% H2Se в аргоне в течение 30 мин. Предпочтительно четверной сплав формулы (III) является гомогенным. Полупроводниковые пленки из четверного сплава CuIn(Se,S)2 Стадии (i) и (ii). Стадии (i) и (ii) являются такими же, как указано выше. Более конкретно стадия (i) включает в себя предоставление металлической пленки, включающей смесь по меньшей мере одного элемента из группыIB и элемента из группы IIIА. Стадия (ii) включает в себя термическую обработку металлической пленки со стадии (i) в присутствии источника элемента VIA1 в условиях, в которых образуется первая пленка,содержащая смесь бинарных сплавов, которые выбирают из группы, состоящей из сплава элементов из групп IB-VIA1 и сплава элементов из групп IIIA-VIA1, причем тройной сплав образуется из элементов групп IB-IIIA-VIA1. В предпочтительном варианте воплощения изобретения элемент IB означает Cu, IIIА означает In иVIA1 означает Se. Предпочтительно металлическая пленка стадии (i) представляет собой Cu-In сплав. В предпочтительном варианте воплощения изобретения первую пленку со стадии (ii) подвергают стадии обработки для того, чтобы обеспечить стабильные свойства смеси бинарных сплавов и тройного сплава со стадии (ii). Предпочтительно источник элемента VIA1 удаляют. Кроме того, первая пленка стадии (ii) может быть охлаждена до температуры ниже 200 С. Стадия (iii). Эту стадию не проводят. Стадия (iv). В одном варианте воплощения изобретения первую пленку со стадии (ii) подвергают термической обработке на первой стадии и затем подвергают термической обработке на второй стадии, где первую пленку со стадии (ii) отжигают в присутствии источника элемента группы VIA2 для того, чтобы образовался сплав элементов из групп IB-IIIA1-VIA1-VIA2. Этап первой термической обработки на стадии (iv) включает в себя нагревание первой пленки со стадии (ii) до реакционной температуры от 100 до 600 С, предпочтительно от 200 до 550 С, и более предпочтительно от 500 до 550 С, в течение 10-60 мин, предпочтительно от 15 до 30 мин. Затем первую пленку со стадии (ii) отжигают в присутствии источника элемента группы VIA2. Предпочтительным элементом группы VIA2 является S. Предпочтительно первую пленку со стадии (ii) отжигают в присутствии источника серы в течение 10-60 мин, более предпочтительно 30 мин, при температуре от 200 до 600 С, предпочтительно от 200 до 550 С, более предпочтительно при 500 С для того,чтобы образовался четверной сплав формулы (IV), в которой IB означает Cu, IIIA означает In, VIA1 означает Se и VIA2 означает S где у может изменяться от 0,1 до 0,5. Предпочтительно источником серы является атмосфера H2S и по меньшей мере одного другого газа, предпочтительно инертного газа, такого как Ar. Предпочтительно молярная концентрация S относительно по меньшей мере одного другого газа составляет 0,35%. В предпочтительном варианте воплощения изобретения первую пленку (ii) подвергают обработке на следующих последовательных стадиях:(a) нагревание первой пленки в реакционной трубке до реакционной температуры от 500 до 550 С за 15-30 мин; и(b) отжиг первой пленки в присутствии газообразной смеси H2S и Ar (газ), в которой молярная концентрация S относительно Ar (газ) составляет 0,35, чтобы образовался четверной сплав формулы (IV).-8 009012 Предпочтительно четверной сплав формулы (IV) является гомогенным. Подробное описание изобретения Теперь варианты воплощения изобретения будут описаны с помощью следующих примеров, которые не ограничивают объем изобретения и приведены только для его иллюстрации. В этих примерах сделаны ссылки на сопровождающие чертежи: фиг. 1 представляет собой схематическое изображение способа получения полупроводниковой пленки из пятеричного сплава элементов из групп IB-IIIA-VIA согласно изобретению; фиг. 2.1-2.2 представляют собой дифракционные рентгенограммы (XRD) первой пленки, образовавшейся в соответствии со стадией (ii) примера 1. Более конкретно фиг. 2.1 представляет собой дифрактограмму XRD первой пленки образца 200250-а, и фиг. 2.2 представляет собой дифрактограмму XRD первой пленки образца 200251-а; фиг. 3 представляет собой дифракционные рентгенограммы, соответствующие стадии (iii) и стадиям (iv)(a) и (iv)(b) по примеру 1 для образца 200251-а; эти рентгенограммы иллюстрируют переход тройного сплава в состояния четверного и пятеричного сплава для этого образца; фиг. 4.1-4.2 представляют собой дифрактограммы GIXRD для положений пика [112] в полупроводниковых пленках пятеричного сплава для образцов 200251-а и 200250-а в примере 1; фиг. 5 представляет собой дифрактограмму XRD образца 2003078-а примера 1; фиг. 6 представляет значения фотоэдс (VOC) для ряда фотоэлектрических преобразователей, имеющих полупроводниковые пленки из образца 200251-а; фиг. 7 представляет собой график квантовой эффективности (QE) для образца 200290-а из примера 1; фиг. 8 представляет собой дифрактограмму XRD полупроводниковой пленки из сплава(образец 200376-с); полупроводниковой пленки из сплава(образец 200251-а) и полупроводниковой пленки из сплаваCu(In0,75Ga0,25)(Se0,6S0,4)2 (образец 200250-а) из примера 1; фиг. 9 демонстрирует график квантовой эффективности (QE) для полупроводниковой пленки из гомогенного сплава Cu(In0,75Ga0,25)(Se0,75S0,25)2 (образец 200251-а) из примера 1; фиг. 10 - это зависимость ширины запрещенной зоны от отношения S/(Se+S) для ряда гомогенных пятеричных сплавов, полученных в соответствии со стадиями, описанными в примере 1; фиг. 11-13 представляют собой микрофотографии (SEM) с изображением морфологии поверхности полупроводниковой пленки из сплава Cu(In0,75Ga0,25)(Se0,75S0,25)2 (образца 200251-а), полупроводниковой пленки из сплава Cu(In0,75Ga0,25)(Se0,6S0,4)2 (образца 200250-а) и полупроводниковой пленки из сплаваCu(In0,75Ga0,25)(Se0,3S0,7)2 (образец 200378-а) из примера 1; фиг. 14 - это профиль концентрации по глубине пятеричного сплава из примера 1, и более конкретно, профиль концентрации для образца 200251-а (измерен методом XPS); фиг. 15.1-15.2 представляют собой дифрактограммы XRD четверного сплава, полученного в условиях уровня техники, конкретно указанных в примере 2 и четверного сплава из примера 2, конкретно образца 200259-а; фиг. 16 представляет собой дифрактограмму GIXRD для положения пика [112] для образца 200259 а из примера 2; фиг. 17.1-17.2 представляют собой профили рентгеновской флуоресценции, демонстрирующие изменение по глубине состава четверного сплава, полученного в условиях уровня техники, указанных в примере 2, и образца 200259-а из примера 2, соответственно; фиг. 18 профиль концентрации по глубине четверного сплава из примера 2 и более конкретно профиль концентрации для образца 200259-а (измерен методом XPS); фиг. 19 представляет собой дифрактограмму XRD четверного сплава, полученного в условиях уровня техники, указанных в примере 3; фиг. 20 представляет собой микрофотографию (SEM) с изображением морфологии поверхности четверного сплава, полученного в условиях уровня техники, указанных в примере 3; фиг. 21 представляет собой микрофотографию (SEM) с изображением морфологии поверхности образца 200259-с из примера 3; фиг. 22 представляет собой дифрактограмму XRD образца 200259-с из примера 3; фиг. 23 представляет собой профиль концентрации по глубине четверного сплава из примера 3 и более конкретно профиль концентрации по глубине для образца 200258-b (измерен методом XPS); фиг. 24 представляет собой дифрактограмму GIXRD для положения пика [112] для образца 200263b из примера 3. Для определения сплавов элементов из групп IB-IIIA-VIA согласно изобретению были использованы следующие методы исследования и соответствующие условия: 1. XPS: профили концентрации в образцах определяют методом рентгеновской фотоэмиссионной спектроскопии (XPS), с помощью сканирующей XPS системы Physics Electronics (PHI) Quantum 2000,используя Al K излучение с энергией луча 20 Вт. Размер пятна составляет 100 мкм, и аргоновая ионная пушка работает при 2 кВ.-9 009012 2. XRD: изображение дифрактограмм рентгеновских лучей (XRD) регистрируют с использованием дифракционной системы Phillips X'pert с Cu K излучением (0,154056 ) при 40 кВ и токе 40 мА. 3. SEM: для изучения морфологи и состава пленок используют соответственно сканирующий электронный микроскоп (SEM) Jeol JSM 5600, оборудованный приставкой Noran EDS при 20 кВ, с вертикально падающим лучом при 20 кВ. 4. GIXRD: параметры решетки в зависимости от глубины образца по XRD определяют рентгеновской спектроскопией под малым углом измерения (GIXRD) в системе Phillips X'pert PW3040-MPD с CuK излучением (0,154056 ) при 40 кВ и 40 мА. 5. Устройства с солнечными батареями исследуют в стандартных условиях солнечного излучения(A.M.=1,5; 100 мВтсм-2) при 25 С. Спектральный отклик соответствующих устройств определяют из измерений квантовой эффективности. Соответствующие значения ширины запрещенной зоны для поглощающих пленок определяют из величин верхней критической длины волны при измерениях спектрального отклика. Общая методика эксперимента Как хорошо известно специалистам в этой области техники, фотоэлектрические преобразователи включают подложку, на которую наносят полупроводниковую пленку, в данном случае, полупроводниковую пленку из сплава элементов групп IB-IIIA-VIA. Обычно может быть использована любая подходящая подложка, которая не взаимодействует с полупроводниковой пленкой и которая не изменяет свойства полупроводника. Подходящие подложки включают стекло, гибкую металлическую или полимерную фольгу и т. п. Подложка может иметь толщину от 0,05 до 3,0 мм и часто имеет покрытие из слоя металлического молибдена для того, чтобы усилить адгезию образовавшейся полупроводниковой пленки к подложке и чтобы выполнять функцию контакта в готовом фотоэлектрическом устройстве. Обычно толщина молибденового покрытия составляет между 0,5 и 1,0 мкм, причем покрытие осаждают на подложку с помощью магнетронного распыления при постоянном токе, при рабочем давлении между 0,1 и 0,8 Па. Следует принять во внимание, что из уровня техники известно множество других способов, которые относятся к применению и осаждению металлических слоев, например, можно нанести больше одного слоя, или вместо молибдена может быть использован хром. Стадия (i). С целью осуществления эксперимента используют в качестве подложки натриевое стекло толщиной 2 мм. Подложку очищают в мыльном растворе, перемешиваемом с помощью ультразвука в течение 10 мин, при осторожном перемещении подложки, вставленной в держатель. Затем подложку выдерживают в течение нескольких минут в холодной деионизированной воде, обеспечивая удаление избытка мыла с подложки. Затем подложку очищают в бане с горячей деионизированной водой, перемешиваемой с помощью ультразвука, при осторожном перемещении держателя с подложкой. Подложку окончательно сушат в течение 10 мин в сухом азоте, в шкафу при постоянной температуре 120 С. После высушивания на подложку осаждают слой Мо. После этого проводят совместное напыление металлических пленок Cu, Ga и In на слой Мо для получения полупроводниковой пленки из сплаваCu(In1-xGax)Se2 и полупроводниковой пленки из сплава Cu(In1-xGax)(Se1-ySy)2. В случае получения полупроводниковой пленки из сплава CuIn(Se1-ySy)2 на подложку совместно напыляют Cu и In. Осаждение молибдена и совместное напыление осуществляют при постоянном токе в блоке магнетронного распыления, состоящем из камеры осаждения, в которой размещены три 9-дюймовых круглых катода (мишени): мишень из Мо, чистого In и сплава Cu0,75Ga0,25, или, в случае получения полупроводниковой пленки из сплава CuIn(Se1-ySy)2, мишени представляют собой Мо, Cu и In. Камеру осаждения откачивают до остаточного давления 510-5 Па по меньшей мере в течение 3 ч. Слой Мо осаждают без какого-либо специального нагревания подложки, при рабочем давлении от 0,5 до 0,7 Па, используя Ar в качестве газа плазмы. Общая толщина слоя Мо составляет 1 мкм. Пример 1. Методика эксперимента для получения пятеричного сплава из элементов групп IB-IIIAVIA. На фиг. 1 схематически представлен способ согласно изобретению для получения полупроводниковой пленки из пятеричного сплава элементов из групп IB-IIIA-VIA. Стадия (i). Стадию (i) проводят, как описано в общей методике эксперимента. Более конкретно после осаждения слоя Мо осуществляют без выключения вакуума, совместное напыление Cu0,75Ga0,25 и индия при рабочем давлении 0,3 Па. Совместное напыление металлов, Cu, In и Ga, также проводят без специального нагревания подложки, причем в ходе совместного напыления подложка вращается, для того чтобы усилить перемешивание Cu-Ga-In сплава. Общая толщина Cu-In-Ga сплавов составляет 0,6 мкм, причем атомные отношения Cu/(In+Ga) и Ga/(Ga+In) равны соответственно 0,9 и 0,25. Стадия (ii). Подложку вместе с напыленной металлической пленкой со стадии (i) помещают в горизонтальный трубчатый реактор из кварца (в последующем называется трубчатый реактор). Подложку кладут на гра- 10009012 фитовый держатель подложки и помещают в трубчатый реактор. Графитовый держатель используется для обеспечения равномерного нагрева подложки. Трубчатый реактор откачивают до давления 2,6710-4 Па по меньшей мере в течение 2 ч, до осуществления стадии (ii). Затем трубчатый реактор герметизируют и подают постоянный ток Ar, 1300 стандартных кубических сантиметров в минуту (в последующем используется сокращение мл/мин), поддерживаемый в ходе реакции. После установления постоянного тока инертного газа температуру подложки с металлической пленкой линейно повышают до температуры реакции, указанной ниже в табл. 1, в течение 5 мин. Через трубчатый реактор пропускают реакционную газовую смесь (0,12 мол.% H2Se в аргоне), в то время как подложку нагревают при температуре реакции, указанной в табл. 1, в течение периода реакции, также указанного в табл. 1, чтобы образовалась первая пленка, которая включает в себя стабильную смесь бинарных сплавов, а именно CuSe, InSe и Ga2Se3, и следующие тройные сплавы, а именно CuInSe2 и CuGaSe2. Образование одного или двух тройных сплавов зависит от температуры реакции на стадии(ii), причем, как будет показано ниже, при 400 С сплав CuGaSe2 не образуется. Из рассмотрения фиг. 2.1, которая представляет собой дифрактограмму XRD для первой пленки,полученной на стадии (ii) в условиях реакции, указанных в табл. 1 для образца 200250-а, видно, что в пленке присутствует смесь трех бинарных сплавов и CuInSe2. В указанных условиях реакции для образца 200250-а отсутствуют доказательства образования CuGaSe2 при 400 С. Как видно из рассмотрения фиг. 2.2, которая представляет собой дифрактограмму XRD для первой пленки, полученной на стадии (ii) в условиях реакции, указанных ниже в табл. 1 для образца 200251-а,отражения от плоскостей [112], [220/204] и [312/116] включают в себя (а) относительно резко выраженные положения пиков, соответствующих CuInSe2, и (б) плечи, обусловленные наличием CuGaSe2 и остатками бинарных сплавов CuSe и Ga2Se3. После завершения периода реакции, указанного в табл. 1, образцы подвергают стадии обработки,чтобы дополнительно повысить стабильность полученной смеси. Эту стадию осуществляют путем прерывания потока H2Se в трубчатый реактор и быстрого охлаждения образцов до температуры ниже 200 С. Образцы выдерживают в указанных выше условиях в течение 15 мин, чтобы обеспечить полное удаление частиц H2Se из трубчатого реактора. На обеих фиг. 2.1 и 2.2 изображены дифрактограммы стабильных смесей, для которых в условиях реакции, приведенных ниже в табл. 1, предотвращено протекание реакции до конца, и, таким образом,образуются полностью прореагировавшие тройные сплавы CuInSe2 и CuGaSe2, в отсутствие CuSe, InSe иGa2Se3, как в случае уровня техники. Авторы этого изобретения полагают, что при недостатке в системе селена, за счет применения очень низких концентраций Se и низких температур для того, чтобы предотвратить завершение реакции селенизации с образованием полностью прореагировавших тройных сплавов, могут быть получены такие стабильные смеси, которые приведены на фиг. 2.1 или 2.2. Таблица 1 Условия реакции (температура и время) на стадии (ii) согласно изобретению Стадия (iii). Затем первую пленку со стадии (ii), образовавшуюся в условиях реакции, указанных выше в табл. 1,нагревают в трубчатом реакторе в газообразной смеси H2S и Аr (молярный процент серы в этой газообразной смеси поддерживают около 0,35% относительно Ar) при температуре реакции 450 С, в течение 5 мин, для того чтобы бинарные сплавы реагировали с серой с превращением первой пленки со стадии (ii) во вторую пленку, содержащую смесь сульфоселенидов, а именно Cu(Se,S), In(Se,S) и Ga(Se,S), и тройные сплавы со стадии (ii). Из рассмотрения фиг. 3, которая представляет собой дифрактограмму XRD для образца 20051-а, и в частности XRD на стадии (iii), видно наличие In(Se,S), однако, остатки сульфоселенидов Cu(Se,S) иGa(Se,S) не проявляются в выбранном диапазоне углов 2. Авторы изобретения полагают, что при температуре около 450 С, как свидетельствуют данныеXRD для продукта стадии (iii), реакция между серосодержащими соединениями в газовой фазе и тройными сплавами со стадии (ii) (на которые указывают пики 1 при 26,71 и 2 при 27,75 на фиг. 3) является,по существу, незначительной. Другими словами, взаимодействие между S и тройными сплавами при- 11009012 этой конкретной температуре является незначительным. Стадия (iv). Затем вторую пленку со стадии (iii) подвергают термической обработке в трубчатом реакторе на следующих этапах.(а) Термически обрабатывают вторую пленку со стадии (iii) при температуре около 500 С в течение 5 мин таким образом, что сульфоселениды взаимодействуют с тройными сплавами с образованием третьей пленки, включающей в себя четверные сплавы CuIn(Se1-ySy)2 и CuGa(Se1-ySy)2 (на которые указывают пики 3 при 27,01 и 4 при 28,05 в XRD продукта стадии (iv)(a. Авторы изобретения полагают, что в случае осуществления этой стадии (ii) при температуре 400 С,и в отсутствие CuGaSe2, сульфоселениды могут непосредственно реагировать с образованиемCuGa(Se1-ySy)2 на этой стадии. Однако в таком случае образовавшийся четверной сплав будет иметь большее содержание серы, что приведет к сдвигу положения пика 4 в сторону к большему значению 2,чем это наблюдается на фиг. 3. Взаимодействие S с тройными сплавами на стадии (ii) характеризуется отсутствием сульфоселенидов, например, в дифрактограмме XRD продукта стадии (iv)(a) на фиг. 3 отсутствует пик In(Se,S), отсюда можно заключить, что это соединение взаимодействует с CuInSe2 с образованием CuIn(Se1-ySy)2. Из сопоставления дифрактограмм XRD продукта стадии (iii) на фиг. 3 с данными XRD на стадии(iv)(a) (фиг. 3) и последующего изменения угла 2 становится ясно, что тройные сплавы (характеризуются пиками 1 и 2 отражения от [112]) прореагировали с сульфоселенидами с образованием третьей пленки,содержащей четверные сплавы CuIn(Se1-ySy)2 и CuGa(Sei1-ySy)2 (представлены пиками 3 и 4 отражения от[112]). Степень сдвига пика [112] из положения 1 в 3, и из положения 2 в 4 определяется объемной долей сульфоселенидов, доступных для взаимодействия с тройными сплавами. В свою очередь, объемная доля сульфоселенидов зависит от объемной доли бинарных сплавов, находящихся в первой пленке со стадии(ii), которая регулируется изменением условий реакции на стадии (ii). Когда при температуре около 500 С образуются стабильные, полностью прореагировавшие четверные сплавы, протекание реакции начинает лимитироваться диффузией и дальнейшее взаимодействие со смесью H2S/Ar при 500 С в течение длительного периода оказывает незначительное влияние на состояние кристаллической фазы и содержание серы в композиционном сплаве.(b) Отжигают третью пленку со стадии (iv)(a) в трубчатом реакторе при температуре 550 С в течение периода 15 мин, так чтобы четверные сплавы CuIn(Se1-ySy)2 и CuGa(Se1-ySy)2 взаимодействовали с образованием полупроводниковой пленки из пятеричного сплава Cu(In1-xGax)(Se1-ySy)2 (в котором х может изменяться между 0,1 и 0,5, предпочтительно между 0,25 и 0,3, а значение у может быть между 0 и 1,предпочтительно между 0,05 и 0,5). Переход из состояния четверного сплава в пятеричный сплав (характеризуется пиком 5 при 27,2 в XRD продукта стадии (iv)(b) на фиг. 3) происходит через 10-15 мин взаимодействия с H2S, хотя обычно требуются дополнительные 15 мин отжига для того, чтобы оптимизировать структурные свойства пятеричного сплава. Важно отметить, что содержание серы в пятеричном сплаве Cu(In1-xGax)(Se1-ySy)2 зависит от содержания серы в четверных сплавах CuIn(Se1-ySy)2 и CuGa(Se1-ySy)2, a значения х и у зависят от объемной доли сульфоселенидов. Фактически, эта зависимость может быть выражена математически, как показано на фиг. 1, так что содержание серы (т. е. значение z на фиг. 1) в конечном пятеричном сплаве определяется по концентрации серы в соответствующих четверных сплавах (т. е. значения х и у на фиг. 1). Эта зависимость может быть выражена математически как z-(х+у)/2. Значение z в конечном счете определяет величину угла 2 для дифракционных пиков [112] пятеричных сплавов и, соответственно, параметры решетки и ширину запрещенной зоны сплава. С экспериментальной целью обе стадии (iii) и (iv) проводятся последовательно в смеси реакционноспособного газа H2S, в ходе которых температура линейно повышается от 450 до 550 С. После завершения обеих стадий (iii) и (iv) трубчатый реактор откачивают до давления 2,6710-4 Па по меньшей мере в течение 2 ч, чтобы обеспечить полное удаление токсичных газов из трубчатого реактора. Затем давление в трубке повышают и удаляют образцы. Авторы изобретения полагают, что в случае осуществления способа, как указано выше, образуется,в основном, однородная полупроводниковая пленка из пятеричного сплава, имеющая улучшенные свойства, по сравнению с полупроводниковыми пленками, полученными в способах уровня техники. Обсуждение характеристик полупроводниковых пленок из Cu(In1-xGax)(Se1-ySy)2 сплава,полученных по способу изобретения Образцы, приведенные выше в табл. 1, обрабатывают на стадиях (iii) и (iv) для того, чтобы получить, в основном, гомогенные полупроводниковые пятеричные сплавы. В табл. 2 ниже приведены соответствующие данные химического состава, которые определены с помощью энергодисперсионной рентгеновской спектроскопии (EDS), со ссылками на атомные отношения Cu/(In+Ga), Ga/(Ga+In) и S/(Se+S). Кроме того, ниже в табл. 2 приведены данные о ширине запрещенной зоны для каждого образца, а также положение дифракционных пиков [112].- 12009012 Таблица 2 Сводка данных об условиях реакции и их влияния на степень внедрения серы и ширину запрещенной зоны в полученных образцах Из сопоставления первых четырех образцов в табл. 2 ясно видно влияние условий стадии (ii) изобретения на степень внедрения серы, которая охарактеризована отношением S/(S+Se) в таблице. Соответственно, путем изменения условий стадии (ii) видоизменяется кинетика последующей реакции на стадии (iii) изобретения, что приводит к изменению степени внедрения серы в окончательную полупроводниковую пленку Cu(In0,75Ga0,25)(Se1-ySy)2. Сопоставление образцов 200250-а и 200251-а показывает, что повышение температуры реакции на стадии (ii) от 400 до 450 С приводит к значительному уменьшению внедрения серы и, следовательно, к смещению дифракционного пика [112] к меньшему значению угла. В случае двух последних образцов (т. е. 200251-а и 200252-а) условия реакции на стадии (ii) поддерживают постоянными, в то время как реакционный период отжига полученного композиционного сплава на стадии (iv)(b), указанной выше, увеличивают от 30 до 90 мин. Сопоставление этих образцов ясно показывает, что отжиг в атмосфере H2S/Ar в течение длительного времени, более 30 мин, имеет минимальное влияние на степень внедрения серы. Соответственно, это указывает, что, в основном, гомогенный пятеричный сплав образуется только через 30 мин отжига в среде H2S/Ar при 550 С. Кроме того, предполагается, что после получения полностью прореагировавших гомогенных пятеричных сплавов, протекание реакции начинает лимитироваться диффузией, и дальнейшее внедрение серы обязательно протекает в результате замещения частиц селена. Фиг. 4.1 и 4.2 представляют собой дифрактограммы рентгеновской спектроскопии под малым углом измерения (GIXRD) для отражений [112] в образцах 200251-а и 200250-а, указанных выше в табл. 2. В этом методе идентификации уменьшение значения угла падения приводит к снижению глубины проникновения рентгеновских лучей. Важно отметить, что разброс значений углов между 0,2 и 10 практически не приводит к изменению параметров решетки между поверхностью и объемом образцов, что подтверждает однородность пятеричных сплавов. Аналогичное значение имеет тот факт, что изменение условий стадии (ii) приводит к значительному смещению 2-положения дифракционных пиков [112]. Поскольку содержание галлия является практически постоянным во всех композиционных сплавах, это относительное изменение приписывается изменению степени внедрения серы. Ниже в табл. 3 показаны различные изменения значений угла 2, и в табл. 4 показаны соответствующие изменения d-параметров для некоторых пятеричных сплавов из табл. 2.- 13009012 Таблица 3 Сводка положений отражения от плоскости [112] при различных значениях угла падения излучения. Общее смещение положения пика рассчитывают как разность между положениями пика отражения [112] при углах 0,5 (вблизи поверхности) и 10 (в объеме) для образцов Таблица 4 Сводка положений d-параметров (в Ангстремах) отражения от плоскости [112] при различных значениях угла падения излучения. Общее изменение d-параметра рассчитывают как разность между параметрамиd, измеренными при углах 0,5 (вблизи поверхности) и 10 (в объеме) образцов Общее изменение d-параметра показывает, что образцы сплавов полупроводниковых пленок, полученных по способу согласно изобретению, характеризуются кристаллической структурой, включающей в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,001. На фиг. 5 изображены положения дифракционных пиков отражения от [112] для предшественникаCuIn0,75Ga0,3, который сначала (i) был селенизирован и после этого (ii) был сульфидирован в условиях стадии (iv) (см. табл. 2 для образца 2003078-а). Экспериментальные условия в ходе селенизации/сульфидирования регулировались таким образом, чтобы получить пятеричный сплав (образец 2003078-а) с высоким содержанием серы (т.е. S/(Se+S)=0,7). Пик (i) при 26,60 представляет собой ожидаемое положение [112] для CuInSe2 после селенизации. Асимметричный характер пика на этой стадии получения приписывается ступенчатому изменению содержания (сегрегированию) Ga. Однако важно отметить, что положение пика [112] смещается к значению угла 27,8 после сульфидирования. Если использовать закон Вегарда (Vegard) и принять концентрацию Ga равной около 25%, то это смещение соответствует содержанию серы около 70%, следовательно, сплав Cu(In0,7Ga0,3)(Se0,3S0,7)2 является гомогенным. Эти предположения были подтверждены с помощью измерений EDS. Особенно важно отметить, что пик (ii) является симметричным, без каких-либо признаков композиционного уширения. Ширина запрещенной зоны для образца 2003078-а, определенная из измерений квантовой эффективности (QE), равна 1,4 эВ (см. фиг. 7). Хотя такая ширина запрещенной зоны, возможно, слишком велика для оптимальной эффективности преобразования, из приведенного выше ясно, что гомогенный материал может быть получен даже при высоком содержании серы в пленках. На фиг. 8 изображено положение пика [112] для различных гомогенных сплавов Cu(In,Ga)(Se,S)2,полученных согласно указанному выше способу, более конкретно положение пиков [112] для образца 2003076-с, образца 200251-а и образца 200250-а. И в этом случае предполагается, что концентрация Ga в предшественнике остается постоянной, и условия реакции селенизации/сульфидирования подбираются таким образом (как показано в табл. 2), чтобы контролировать степень внедрения серы и, следовательно,параметры решетки. Из фиг. 8 можно увидеть, что положение пиков [112] изменяется между 26,9 и 27,4, что соответствует атомным отношениям S/(Se+S) между 0,05 и 0,4, как указано в табл. 2 для образца 2003076-с, образца 200251-а и образца 200250-а. Последние значения и в этом случае оценивали из закона Вегарда, принимая, что пятеричный сплав является гомогенным и отношение Ga/(Ga+In) равно 0,25. Для этих конкретных сплавов соответствующее изменение ширины запрещенной зоны лежит между 1,1 и 1,3 эВ. Например, на фиг. 9 показана типичная кривая квантовой эффективности для гомогенного сплава- 14009012 зависимость ширины запрещенной зоны от отношения S/(Se+S). На фиг. 11-13 изображена типичная морфология поверхности полупроводниковых тонких пленок из сплава Cu(In,Ga)(Se,S)2, полученного в условиях примера 1, с различным содержанием серы и, следовательно, шириной запрещенной зоны. В случае фиг. 11 (образец 200251-а) пик [112] находится в положении 27,2, и соответствующая ширина запрещенной зоны равна 1,20 эВ (см. фиг. 9). Для сплава на фиг. 12 (образец 200250-а) пик [112] находится в положении 27,4. На фиг. 13 (образец 2003078-а) изображены структурные характеристики сплавов с положением пика [112] вблизи 27,8; соответствующее значение ширины запрещенной зоны равно 1,4 эВ, как показано на фиг. 7. Из фиг. 11-13 можно увидеть, что полученные сплавы имеют относительно однородную морфологию поверхности с типичным размером зерна приблизительно 1 мкм. На фиг. 14 представлен концентрационный профиль элементов Cu, In, Ga, Se и S по глубине образца 200251-а. В основном гомогенная природа образца видна из профиля концентрации: содержание элементов во всем сплаве является практически постоянным вплоть до металлического слоя молибдена. Определение значения фотоэдс для различных устройств солнечных элементов, содержащих полупроводниковые пленки из, в основном, гомогенного пятеричного сплава, полученного в условиях способа согласно изобретению Устройства солнечных элементов были изготовлены в соответствии с методикой получения стандартных элементов, которые включают буферный слой 50 нм CdS и слой окна 50 нм из природного ZnO и 150 нм оксида индий-олова (ITO). Ячеистые структуры стекло/Mo/Cu(In,Ga)(Se,S)2/CdS/ZnO исследовали в условиях искусственного освещения (A.M.=1,5) при 25 С. Как видно из табл. 2, значения ширины запрещенной зоны для, в основном, гомогенных пятеричных сплавов изменяются за счет варьирования условий реакции на стадии (ii). Соответствующие параметры ячейки приведены ниже в табл. 5. Таблица 5 Сводка параметров ячейки для различных фотоэлектрических устройств, в которых полупроводниковые пленки представляют собой, в основном,гомогенный пятеричный сплав с различной шириной запрещенной зоны Эффективность преобразованияочень сильно связана с шириной запрещенной зоны образца сплава и изменяется между 8 и 15%, причем самым эффективным является устройство с образцом 200375-b, имеющим наименьшую ширину запрещенной зоны. Все устройства имеют значения фотоэдс(VOC) выше 600 мВ. Кроме того, были изготовлены 24 фотоэлектрических преобразователя, включающих полупроводниковые пленки из пятеричного сплава, полученного в условиях реакции, описанных выше для образца 200251-а. Значения фотоэдс (VOC) для этих ячеек согласуются с величинами от 600 до 640 мВ (см. фиг. 6), и авторы изобретения считают это доказательством воспроизводимости способа получения согласно изобретению. Пример 2. Экспериментальная методика получения четверного сплава элементов из групп IB-IIIAVIА. Стадия (i). Стадия (i) является такой же, что описана в общей методике эксперимента. Более конкретно, после осаждения слоя Мо, без отключения вакуума, следует совместное напыление Cu0,75Ga0,25 и In при рабочем давлении равном 0,3 Па. Кроме того, совместное напыление проводят без специального нагревания подложки, причем в процессе совместного напыления подожку вращают для того, чтобы улучшить перемешивание сплава Cu-Ga-In. Общая толщина сплава Cu-In-Ga составляет 0,6 мкм, а атомные отношения Cu/(In+Ga) и Ga/(Ga+In) поддерживают равными 0,9 и 0,25 соответственно. Стадия (ii) В этом случае используют такой же способ, что описан выше для стадии (ii) эксперимента 1, однако, температуру реакции поддерживают равной 400 С для того, чтобы образовалась первая пленка, содержащая стабильную смесь только бинарных сплавов и CuInSe2. Авторы изобретения считают, что в случае получения полупроводниковых пленок из четверного сплава необходимо предотвращать образование второго тройного сплава, а именно CuGaSe2 для того,чтобы получить гомогенный четверной сплав. Это может быть достигнуто путем поддержания температуры реакции 400 С. Как указано выше, первую пленку стадии (ii) подвергают обработке для того, чтобы поддержать- 15009012 стабильность смеси, при этом прерывают поток H2Se, и первую пленку охлаждают до температуры ниже 100 С. В этом случае пленку выдерживают в токе аргона в течение периода по меньшей мере 15 мин,вновь с целью полного удаления частиц H2Se. Стадия (iii). В случае получения полупроводниковой пленки из четверного сплава эту стадию не проводят. Стадия (iv). Первую пленку подвергают обработке на следующих последовательных стадиях:(a) нагревание первой пленки со стадии (ii) в реакционной трубке в инертной атмосфере Ar до реакционной температуры 500 С в течение 5 мин;(b) отжиг первой пленки со стадии (ii) в реакционной трубке, в аргонсодержащей атмосфере при 500 С по меньшей мере в течение 15 мин;(c) отжиг первой пленки в присутствии 0,12 мол.% H2Se в аргоне, в течение 30 мин, при 550 С для того, чтобы образовалась полупроводниковая пленка из гомогенного четверного Cu(In1-xGax)Se2 сплава, в котором х равно от 0,25 до 0,3. Как и в случае образования пятеричного сплава, трубчатый реактор откачивают до давления 2,6710-4 Па по меньшей мере в течение 2 ч, чтобы обеспечить полное удаление токсичных газов из трубчатого реактора. Затем давление в реакторе повышают и образец удаляют. Авторы изобретения считают, что, соблюдая условия реакции и методику, изложенную в примере 2, можно получить, в основном, гомогенные полупроводниковые пленки Cu(In1-xGax)Se2. В условиях, изложенных в эксперименте 2, были получены три образца, причем условия реакции и соответствующий химический состав образцов, который определяется с помощью рентгеновской энергодисперсной спектроскопии (EDS), со ссылками на атомные отношения Cu/(In+Ga) и Ga/(Ga+In), приведены ниже в табл. 6. Таблица 6 Сводка условий реакции и значений ширины запрещенной зоны для полученных образцов Эти исследования проведены в постоянном токе 0,12% H2Se, разбавленном аргоном, для стадии(ii) и 0,12% H2Se, разбавленном аргоном, для стадии (iv)(c). Положения углов 2 пиков отражения [112] для пятеричных сплавов измерены методом GIXRD с медным анодом при 40 кВ. Соответствующие величины ширины запрещенной зоны были рассчитаны по данным измерений квантовой эффективности. Ниже в табл. 7 приведены данные суммарного 2-смещения для указанных выше образцов, и, кроме того, в табл. 8 показано общее изменение соответствующих d-параметров. Таблица 7 Сводка положений [112] отражения при различных значениях угла падения излучения. Общее смещение пиков рассчитывают как разность между положением пиков [112] отражения при углах 0,5 (вблизи поверхности) и 10 (в объеме) для образцов Таблица 8 Сводка положений d-параметров (в Ангстремах) отражений от плоскости [112] при различных значениях угла падения излучения. Общее изменение d-нараметра рассчитывают как разность между d-параметрам,измеренными при углах 0,5 (вблизи поверхности) и 10 (в объеме), образцов Общее изменение d-параметра показывает, что образцы сплавов полупроводниковых пленок, полученные по способу согласно изобретению, характеризуются кристаллической структурой, включающей в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,06 .- 16009012 С целью иллюстрации гомогенных характеристик четверных сплавов, полученных по способу согласно изобретению, был получен образец уровня техники, и были сопоставлены характеристики этого образца и полученного по способу, который изложен в примере 2. На фиг. 15.1 и 15.2 представлены дифрактограммы XRD, изображающие кристаллические особенности типичного сегрегированного четверного сплава (образец уровня техники) и гомогенного четверного сплава (а именно, образца 200259-а) соответственно, причем сплавы были получены способом, изложенным ниже. В обоих случаях измерения были выполнены с помощью Cu K излучения при 40 кВ. В случае сегрегированного четверного сплава (образец уровня техники) (см. дифрактограмму XRD на фиг. 15.1), сплав быстро нагревают меньше чем за 5 мин до 500 С в присутствии H2Se, с последующей стадией отжига в смеси 5 мол.% H2Se в Ar, в течение 60 мин при 500 С. Такая методика приводит к значительной степени взаимной диффузии между фазами, обогащенными In и Ga, причем анализ XRD указывает на наличие структуры сегрегированного Cu(InxGa1-x)Se. Это явление проявляется в виде асимметричного уширения дифракционных пиков отражения от плоскостей [112], [220/204] и [312/116]. В этой связи важно отметить, что положение дифракционного пика [112] при 26,65 еще соответствует параметрам решетки чистой фазы CuInSe2, в то время как плечо пика обусловлено возрастающим количествомGa, что полностью продолжается до положения пика CuGaSe2. Следовательно, разумно принять, что на поверхности поглощающей пленки присутствует чистая фаза CuInSe2 и что содержание галлия постепенно возрастает в направлении молибденового заднего контакта. Второй образец, т.е. образец 200259-а, был получен в описанных условиях эксперимента, изложенных для стадий (i), (ii) и (iv) в примере 2, табл. 6. С целью регулирования скорости взаимодействия бинарных сплавов стадию (ii) проводят при 400 С, используя очень малую концентрацию газа, 0,12 мол.%H2Se в аргоне. Заданное время реакции составляет 30 мин. После полного удаления частиц Se из реакционной зоны первую пленку отжигают в присутствии аргона в течение 15 мин при температуре 500 С, с немедленно следующей стадией отжига в смеси 0,12 мол.% H2Se в аргоне в течение 30 мин. Данные исследования образца 200259-а методом XRD, которые представлены на фиг. 15.2, показывают, что образовавшаяся пленка является гомогенной, причем отсутствуют признаки сегрегированного материала. Резкие, четко выраженные пики [112], [220/204] и [312/116] свидетельствуют о высоком качестве кристаллической структуры. Кроме того, важно отметить, что положение пика [112] смещается приблизительно от 2=26,65, что типично для чистого CuInSe2 (как показано на фиг. 15.1), до значения 2=26,85. Последнее смещение пика [112] в направлении больших значений 2 соответствует уменьшению параметра решетки, связанного с увеличением содержания Ga в четверной системе. Отмеченная степень смещения дифракционных пиков в направлении больших значений 2 точно соответствует закону Вегарда, при допущении гомогенности материала, в котором атомное отношение Ga/(Ga+In) близко к 0,25. На фиг. 16 изображены дифрактограммы GIXRD для пика [112] в образце 200259-а при значениях падающего угла между 0,5 и 10. Вновь следует признать, что уменьшение значения падающего угла излучения приводит к снижению глубины проникновения рентгеновских лучей. Из данных фиг. 16 важно отметить, что рассредоточение значений угла между 0,5 и 10 практически не приводит к изменению параметров решетки между поверхностью и объемом материала; это свидетельствует о том, что пленка является однородной, а не композиционно сегрегированной. Изменение композиционных характеристик четверных сплавов по глубине образца было исследовано методом рентгеновской флуоресценции (XRF). В этом методе исследования образцы неоднократно подвергают травлению бромом в растворе метанола, и после каждого этапа травления проводят измерения интенсивности линии K1,2 в спектре XRF оставшегося материала. По данным этих измерений можно определить химический состав образца уровня техники и образца 200259-а, почти по всей глубине пленки. На фиг. 17.1 приведены данные композиционной однородности по глубине композиционно сегрегированной пленки из сплава Cu(In0,75Ga0,25)Se2 уровня техники (см. фиг. 15.1). На фиг. 17.1 важно отметить, что концентрации элементов Cu и Se фактически остаются постоянными по всей толщине пленки. Можно отметить еще более важный факт, что материал, оставшийся после этапов последовательного травления, постепенно обогащается галлием, в то время как для индия наблюдается обратная тенденция. Полученные значения атомного отношения Ga/(Ga+In) увеличиваются от 0,28 для образца перед травлением до 0,75 после заключительного этапа травления. Это постоянное увеличение атомного отношенияGa/(Ga+In) по глубине образца соответствует сегрегированной фазе Cu(InxGa1-x)Se2, обнаруженной при исследовании образцов методом XRD (см. фиг. 15.1). На фиг. 17.2 приведены данные о композиционных свойствах по глубине образца 200259-а. Можно отметить, что концентрации элементов Cu, In, Ga и Se фактически остаются постоянными по всей толщине пленки из этих конкретных четверных сплавов. Следовательно, эти результаты согласуются с данными XRD, представленными на фиг. 15.2, и подтверждают тот факт, что этот процесс роста исключает сегрегирование галлия и индия в фазе Cu(InxGa1-x)Se2 и приводит к гомогенному четверному сплаву. Гомогенность образца 200259-а иллюстрируется данными концентрационного профиля на фиг. 18,- 17009012 где концентрация элементов Cu, In, Ga и Se является, в основном, постоянной по всему образцу сплава. Пример 3. Экспериментальная методика получения четверного сплава из элементов групп IB-IIIAVIA. Получение CuIn(Se1-ySy)2. Стадия (i). В этом случае, получают металлическую пленку, содержащую только Cu и In, в отличие от предыдущих пленок, которые также содержат Ga. Более конкретно, предшественники металлов Cu и In совместно напыляют на подложку, используя систему магнетронного распыления при постоянном токе, Leybold Z650. В этой системе размещают три отдельных мишени (т.е. Мо, Cu и In), причем подложку непрерывно вращают в процессе напыления для того, чтобы способствовать взаимному перемешиванию Cu иIn. Молибденовый задний контакт (толщиной приблизительно 1 мкм) распыляют из Мо мишени чистотой 5N при рабочем давлении между 0,3 и 0,7 Па. Молибденовую пленку охлаждают в вакууме до комнатной температуры, с последующим совместным напылением слоев Cu и In из медной и индиевой мишеней чистотой 5N. Общая толщина медно-индиевого сплава составляет около 0,6 мкм, и желаемое атомное отношение Cu/In составляет 0,85-0,9; это достигается путем поддержания мощности по Cu постоянной и равной 0,72 Втсм-2, при варьировании мощности по In между 1,0 и 1,4 Втсм-2 в ходе соответствующих процессов осаждения. Все Cu-In слои напыляют при рабочем давлении, равном 0,5 Па. Стадия (ii). В этом случае используют методику, аналогичную описанной для примера 2. В трубчатый реактор помещают металлическую пленку, содержащую предшественники Cu и In, и реактор откачивают до давления 110-4 Па, чтобы удалить все следы компонентов атмосферы. Смесь реакционных газов (приблизительно 0,12% H2Se в аргоне) пропускают через трубчатый реактор при нагревании подложки при температуре между 350 и 450 С, в течение периода между 10 и 60 мин для того, чтобы образовалась пленка,содержащая стабильную смесь InSe, CuSe и CuInSe2. Сразу после селенизации металлической пленки, первую пленку быстро охлаждают и прекращают подачу газовой смеси, чтобы сохранить стабильную смесь сплавов. Стадия (iii). В случае получения полупроводниковой пленки из четверного сплава эту стадию не проводят. Стадия (iv). Стадия термической обработки (iv) включает в себя первую термическую обработку первой пленки со стадии (ii) при желаемой температуре реакции от 500 до 550 С по меньшей мере в течение 30 мин. Затем первую пленку со стадии (ii) последовательно отжигают в присутствии газообразной смесиH2S в аргоне (0,35 мол.% H2S в Ar) в течение периода 30 мин при температуре около 550 С. В ходе указанной выше стадии присутствующие бинарные сплавы CuSe и InSe взаимодействуют с серой с образованием сульфоселенидов Cu(Se,S) и In(Se,S), причем эти сульфоселениды, в свою очередь,реагируют с тройным сплавом CuInSe2 с образованием сплава полупроводниковой пленки CuIn(Se1-ySy)2. Как и в случае образования пятеричного сплава, трубчатый реактор откачивают до давления 2,6710-4 Па по меньшей мере в течение 2 ч, чтобы обеспечить полное удаление токсичных газов из трубчатого реактора. Затем давление в реакторе повышают и образцы удаляют. И в этом случае авторы изобретения считают, что, при соблюдении условий реакции и методики,изложенной в примере 3, можно получить, в основном, гомогенные полупроводниковые пленкиCuIn(Se1-ySy)2. В условиях, описанных для эксперимента 3, были приготовлены три образца, причем условия реакции и соответствующий химический состав образцов, который определяется с помощью рентгеновской энергодисперсионной спектроскопии (EDS), со ссылками на атомные отношения Cu/In и S/(Se+S), приведены ниже в табл. 9. Таблица 9 Сводка условий реакции и соответствующих значений ширины запрещенной зоны для полученных образцов Ниже в табл. 10 приведены величины общего смещения угла 2 для указанных выше образцов, и в табл. 11 также приведены величины общего изменения соответствующих d-параметров.- 18009012 Таблица 10 Сводка положений [112] отражения при различных значениях угла падения излучения. Общее смещение пиков рассчитывают как разность между положением пика [112] отражения при угле 0,5 (вблизи поверхности) и 10 (в объеме) для образцов Эти исследования проведены в постоянном токе 0,12% Н 2Sе, разбавленном аргоном, для стадии(ii) и 0,35% H2S, разбавленном аргоном, для стадии (iv)(c). Положения углов 2 пиков отражения [112] для пятеричных сплавов измерены методом GIXRD с медным анодом при 40 кВ. Соответствующие величины ширины запрещенной зоны были рассчитаны по данным измерений квантовой эффективности. Таблица 11 Сводка положений d-параметров (в Ангстремах) отражений от плоскости [112] при различных значениях угла падения излучения. Общее изменение d-параметра рассчитывают как разность между между dпараметром, измеренным при угле 0,5 (вблизи поверхности) и 10 (в объеме) образцов Общее изменение d-параметров показывает, что образцы полупроводниковой пленки из сплава, полученного по способу согласно изобретению, характеризуются кристаллической структурой, включающей в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения d-параметра меньше чем на 0,007 . Для дополнительной иллюстрации гомогенных характеристик четверных сплавов, полученных по способу согласно изобретению, был приготовлен образец по уровню техники, и его характеристики сопоставлены со свойствами образца, полученного по способу, описанному в примере 3, более конкретно образца 200259-с. Первый образец получают в условиях уровня техники, когда металлическую пленку, содержащуюCu и In, селенизируют при 450 С в течение 60 мин, чтобы получить пленку из полностью прореагировавшего сплава CuInSe2. Затем образец последовательно сульфидируют при 550 С в течение 30 мин. На фиг. 19 изображена дифрактограмма XRD для образца 200259-с. Важно отметить, что способ взаимодействия по уровню техники приводит к образованию двух отдельных тройных фаз, а именно CuInSe2 и CuInS2. Положение дифракционного пика [112] при значении угла 26,68 соответствует параметрам решетки CuInSe2, тогда как положение пика при 27,84 соответствует параметрам решетки CuInS2. Слабый пик отражения, находящийся вблизи 27, указывает на образование четверной фазы CuIn(Se,S)2. Это явление аномального роста относится к неконтролируемой диффузии селена из образца во время сульфидирования, что приводит к быстрому внедрению серы. В конечном счете, это приводит к образованию сплава, содержащего главным образом отдельные фазы CuInSe2 и CuInS2 В предельных случаях сульфидирования в течение 60 мин или более селен в образце полностью замещается серой, что приводит к образованию сплава CuInS2. При исследовании методом SEM (см. фиг. 20) выявлена ожидаемая неоднородная структурная природа гетерогенного сплава. Обычно эти пленки состоят из больших, гладких кристаллитов, внедренных в мелкозернистый материал. Фиг. 21 представляет собой SEM микрофотографию сплава CuIn(Se0,7S0,3)2 (образец 200259-с). Эта пленка сплава характеризуется плотной и относительно однородной структурой с типичным размером зерен около 1 мкм. На фиг. 22 изображен пик отражения от плоскости (112) образца 200259-с. С целью сравнения, на фиг. 22 пунктирными линиями обозначены теоретически ожидаемые 20-положения для отражений (112) от чистых фаз CuInSe2 и CuInS2. Важно отметить, что угол отражения (112) для пленкиCuIn(Se,S)2 после внедрения серы возрастает приблизительно от 26,63, для чистой фазы CuInSe2 - до 27,1. Это явление непосредственно связано с увеличение d-параметра сплава из-за гомогенного замещения селена частицами серы. Кроме того, дифракционный пик демонстрирует высокую степень симметрии без признаков композиционного уширения или расщепления пика, как в случае, приведенном на фиг. 19. Фиг. 23 представляет собой профиль концентрации для образца 200258-b и демонстрирует тот факт,что сплав образца является, в основном, гомогенным, поскольку концентрация элементов Cu, In, Se и S является, в основном, постоянной по всей глубине сплава до слоя молибдена. Фиг. 24 представляет собой дифрактограмму GIXRD для образца 200263-b, из которой видно, что образец является, по существу, гомогенным, причем абсолютное смещение угла 2 составляет 4,6% для значений скользящего угла излучения между 0,5 и 10.- 19009012 Приведенное выше описание представляет собой только варианты воплощения изобретения и следует признать, что возможны различные видоизменения его деталей без отклонения от объема и замысла патентуемого изобретения. ФОРМУЛА ИЗОБРЕТЕНИЯ 1. Четырех- и более компонентный полупроводниковый сплав из элементов группы IB-IIIA-VIA,имеющий общую формулу (I) в которой А означает элемент группы IB; В означает элемент группы IIIA; С означает элемент группы IIIА, который отличается от В;D является первым элементом группы VIA (в последующем называется как VI1); Е является вторым элементом группы VIA (в последующем называется как VI2); и каждый из х и у независимо имеют значения от 0 до 1, при условии, что х и у не равны 0 одновременно,причем сплав отличается тем, что на дифрактограмме рентгеновских лучей (XRD) имеется основной[112] пик со значением угла 2 (2[112]) от 26 до 28 для медного излучения при 40 кВ, при этом на дифрактограмме рентгеновской спектроскопии под малым углом измерения (GIXRD) при значении скользящего угла от 0,2 до 10 наблюдается абсолютное смещение угла 2[112] меньше чем на 0,06. 2. Сплав по п.1, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,01 . 3. Сплав по п.1, в котором концентрация элементов А, В, С, D и Е сплава, характеризуемая по глубине профиля в рентгеновском фотоэлектронном спектре (XPS), является, по существу, однородной по всему сплаву. 4. Сплав по п.1, в котором А означает Cu, В означает In, С означает Ga, D означает Se и Е означаетS, причем сплав имеет формулу (II) 5. Сплав по п.4, в котором х имеет значение от 0,25 до 0,3 и у от 0,05 до 0,8. 6. Сплав по п.4, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной[112] пик при значении угла 2 (2[112]) от 26,9 до 28 для Cu излучения при 40 кВ, взятого при значенииd-параметра от 3,3117 до 3,1840 . 7. Сплав по п.4, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10 наблюдается абсолютное смещение значения угла 2[112] меньше чем на 0,01. 8. Сплав по п.4, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,001 . 9. Сплав по п.6, в котором основной [112] пик находится при значении угла 2 от 27,0 до 27,5. 10. Сплав по п.6, в котором основной [112] пик является, в основном, симметричным. 11. Сплав по п.4, в котором ширина запрещенной зоны может изменяться от 1 до 2,4 эВ. 12. Сплав по п.11, в котором ширина запрещенной зоны может изменяться от 1,1 до 1,5 эВ. 13. Сплав по п.4, в котором содержание серы, выраженное атомным отношением S/(Se+S), лежит в пределах от 0,05 до 0,7. 14. Сплав по п.1, в котором А означает Cu, В представляет собой In, С означает Ga, D означает Se и у=0, причем сплав имеет общую формулу (III) 15. Сплав по п.14, в котором х изменяется от 0,25 до 0,3. 16. Сплав по п.14, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей элементарной ячейки наблюдаются изменения d-параметра меньше чем на 0,006 . 17. Сплав по п.14, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной[112] пик при значении угла 2 (2[112]) от 26,8 до 27 для Cu излучения при 40 кВ, взятого при значенииd-параметра от 3,3236 до 3,2990 . 18. Сплав по п.14, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10 наблюдается абсолютное смещение значения угла 2[112] меньше чем на 0,05. 19. Сплав по п.17, в котором основной [112] пик находится при значении угла 2 от 26,85 до 26,9. 20. Сплав по п.17, в котором основной [112] пик является, в основном, симметричным. 21. Сплав по п.14, в котором ширина запрещенной зоны может изменяться от 1,1 до 1,2 эВ. 22. Сплав по п.21, в котором ширина запрещенной зоны может изменяться от 1,15 до 1,18 эВ. 23. Сплав по п.14, в котором содержание галлия, выраженное атомным отношением Ga/(Ga+In),- 20009012 лежит в пределах от 0,25 до 0,3. 24. Сплав по п.1, в котором А означает Cu, В означает In, D означает Se и х=0, причем сплав имеет общую формулу (IV) 25. Сплав по п.24, в котором у изменяется от 0,1 до 0,5. 26. Сплав по п.24, который имеет кристаллическую структуру, включающую в себя элементарные ячейки решетки, в которых для всех кристаллографических плоскостей наблюдаются изменения dпараметра меньше чем на 0,007 . 27. Сплав по п.24, для которого на дифрактограмме рентгеновских лучей (XRD) имеется основной[112] пик при значении угла 2 (2[112]) от 26,80 до 27,3 для Cu излучения при 40 кВ, взятого при значении d-параметра от 3,3236 до 3,2640 . 28. Сплав по п.24, для которого на дифрактограмме GIXRD при значении скользящего угла от 0,2 до 10 наблюдается абсолютное смещение значения угла 2[112] меньше чем на 0,06. 29. Сплав по п.27, в котором основной [112] пик находится при значении угла 2 от 27,0 до 27,2. 30. Сплав по п.24, в котором ширина запрещенной зоны может изменяться от 1,05 до 1,23 эВ. 31. Сплав по п.30, в котором ширина запрещенной зоны может изменяться от 1,15 до 1,20 эВ. 32. Сплав по п.24, в котором содержание серы, выраженное атомным отношением S/(Se+S), лежит в пределах от 0,1 до 0,5. 33. Полупроводниковая пленка, которая включает в себя сплав по п.1. 34. Полупроводниковая пленка по п.33, содержащая подложку, на которую осажден сплав по п.1. 35. Полупроводниковая пленка по п.33, в которой сплав находится в виде слоя, имеющего толщину от 1,5 до 2,0 мкм. 36. Фотоэлектрический преобразователь, включающий полупроводниковую пленку из сплава по п.1. 37. Фотоэлектрический преобразователь по п.36, который имеет эффективность преобразования от 8 до 15%.
МПК / Метки
МПК: H01L 31/032, H01L 31/18, H01L 31/0264
Метки: i-iii-vi, компонентных, групп, полупроводниковые, элементов, сплавов, более, пленки, четырех
Код ссылки
<a href="https://eas.patents.su/30-9012-poluprovodnikovye-plenki-iz-chetyreh-i-bolee-komponentnyh-splavov-elementov-grupp-i-iii-vi.html" rel="bookmark" title="База патентов Евразийского Союза">Полупроводниковые пленки из четырех и более компонентных сплавов элементов групп i-iii-vi</a>
Предыдущий патент: Способ отключения реакционной системы
Следующий патент: Комплексный интерфейсный способ и система для автоматического создания и обработки заказов на фотомаски
Случайный патент: Получение блоков галогенидов редкоземельных металлов












