Способ легирования полупроводникового материала
Номер патента: 23641
Опубликовано: 30.06.2016
Авторы: Форстер Максим, Фурмон Эрванн, Стадлер Джэки, Ловрей Юбер, Айнхаус Роланд
Формула / Реферат
1. Способ легирования полупроводникового материала, содержащий следующие этапы:
обеспечение тигля (1), содержащего сырье (4) упомянутого полупроводникового материала,
размещение легирующего материала (6) в закрытом расходуемом резервуаре (5а), образованном упомянутым полупроводниковым материалом,
помещение резервуара (5а) в тигель (1),
плавление содержимого тигля (1).
2. Способ по п.1, согласно которому закрытый расходуемый резервуар (5а) выполнен герметичным.
3. Способ по п.1 или 2, согласно которому тигель (1) помещают в корпус (7), в котором создают давление ниже атмосферного.
4. Способ по любому из пп.1-3, согласно которому закрытый расходуемый резервуар (5а) располагают в нижней трети сырья (4) полупроводникового материала.
5. Способ по любому из пп.1-4, согласно которому используют дополнительный расходуемый резервуар (5b), размещаемый в том же тигле (1).
6. Способ по п.5, согласно которому расходуемый резервуар (5а) и дополнительный расходуемый резервуар (5b) выполнены из материалов с различными температурами плавления.
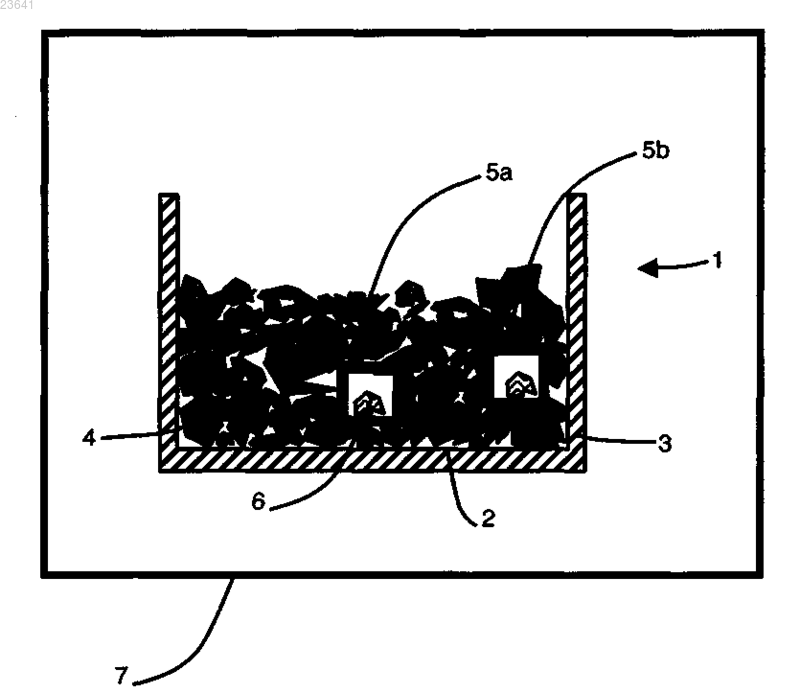
Текст
СПОСОБ ЛЕГИРОВАНИЯ ПОЛУПРОВОДНИКОВОГО МАТЕРИАЛА Сырье (4) полупроводникового материала помещают в тигель (1). Закрытый расходный резервуар(5 а, 5b), содержащий легирующий материал (6), помещают в тигель (1). Содержимое тигля (1) расплавляют, что приводит к внедрению легирующего вещества в ванну расплавленного материала. Изменение температуры выполняется при пониженном давлении. Область техники, к которой относится изобретение Данное изобретение относится к способу легирования полупроводникового материала. Уровень техники В области электроники и фотоэлектроники важно контролировать количество легирующих примесей, присутствующих в кристаллической матрице из полупроводникового материала. Столкнувшись с трудностью производства полупроводникового материала, содержащего необходимые концентрации электрически активных примесей, промышленность пошла по пути устранения последних с целью получения очень слабо легированных материалов. После того, как материал избавлен от этих примесей, ему придают форму, а затем снова легируют другими способами, которые обеспечивают лучший контроль количества легирующих веществ. Этот способ производства является длительным и дорогостоящим, так как требует устранения примесей легирующих веществ, которые впоследствии будут вновь внесены в необходимой концентрации. Когда легирующие вещества необходимо включить в полупроводниковый материал, эти примеси вводят до кристаллизации либо в расплавленное сырье или в само сырье до этапа плавления. Тем не менее, в обоих случаях, окончательное количество легирующих веществ в кристаллическом полупроводниковом материале не всегда соответствует количеству, внесенному в тигель. Обычно используются различные способы для введения легирующих веществ, но все эти способы связаны с риском загрязнения и/или с проблемами контроля точного количества введенных легирующих веществ. Сходным образом,распределение примесей в тигле не является однородным, что приводит к неоднородности с точки зрения электрических свойств полупроводниковых материалов. Цель изобретения Установлено, что существует требование для обеспечения способа легирования полупроводникового материала, который легко реализовать, который является экономичным и обеспечивает хорошее управление количеством введенных легирующих веществ. Способ по настоящему изобретению отличается тем, что он включает в себя следующие этапы: обеспечение тигля, содержащего сырье указанного полупроводникового материала,внесение материала легирующего вещества в закрытом расходуемом резервуаре, расходуемый резервуар формируют из указанного полупроводникового материала,плавление содержимого тигля. Краткое описание чертежа Прочие преимущества и свойства станут более очевидными из последующего описания конкретных вариантов осуществления по настоящему изобретению, которые приведены для целей неограничивающих примеров и представлены в прилагаемом чертеже. Весь чертеж схематическим образом в поперечном сечении изображает тигель, содержащий сырье полупроводникового материала, обеспеченное вместе с расходуемым резервуаром. Осуществление изобретения Как показано на фиг. 1, тигель 1 имеет нижнюю 2 и боковые стенки 3. Тигель 1 заполняют сырьем 4 полупроводникового материала. Данный полупроводниковый материал является, например, кремнием,кремний-германиевым сплавом, SiC, бинарным соединением III-V или II-VI типа, таким как GaAs иCdTe, или тройным соединением III-V или II-VI типа, таким как AIGaAs или HgCdTe. В зависимости от целевого технологического сектора сырье 4 полупроводникового материала включает в себя четко определенные уровни электрически активных примесей легирующих веществ. Данные примесные уровни определяют таким образом, чтобы создать твердый полупроводниковый материал, совместимый с выбранным применением. Для применения в области микроэлектроники сырье 4 полупроводникового материала легируют очень слабо. Для применения в фотоэлектронике сырье 4 полупроводникового материала может содержать большее количество примесных уровней. Распределение примесей в сырье 4 до плавления является свободным. Сырье 4 может содержать очень слабо легированный полупроводниковый материал наряду с более сильно легированным блоком полупроводникового материала. Сырье 4 может также содержать один или несколько блоков легирующего материала внутри тигля 1. Для того, чтобы в результате получить требуемую концентрацию примесей в кристаллическом материале, сырье 4 анализируют для измерения количества присутствующего полупроводникового материала, количества присутствующих легирующих веществ и количества примесей, которые необходимо ввести. Этот шаг может быть выполнен в любое время до расплавления шихты. Закрытый расходуемый резервуар 5, содержащий один или несколько легирующих материалов 6,помещают в сырье 4 полупроводникового материала внутри тигля 1. В конкретном варианте осуществления множество закрытых расходуемых резервуаров 5 размещают в сырье 4. Резервуары могут быть распределены любым образом или их распределение может быть выбрано так, чтобы получить очень хорошую однородность с самого начала плавления. Дополнительный расходуемый резервуар, присутствующий в сырье, может содержать те же легирующие вещества или смеси легирующих веществ, что и расходуемый резервуар. В другом варианте осуществления дополнительный расходуемый резервуар содержит различные легирующие вещества из расходуемого резервуара. Использование нескольких резервуаров 5 а, 5b, содержащих одинаковые примеси или отличные примеси, повышает однородность в расплавленной шихте. Это также позволяет использовать резервуары 5 а, 5b с различными температурами плавления, тем самым позволяя легирующим добавкам включаться постепенно в исходное сырье или избежать одновременного включения двух различных примесей. Далее, является преимуществом использование расходуемых резервуаров 5, которые обладают различными температурами плавления. Резервуар 5 является расходуемым, так как его расплавляют, чтобы он стал частью сырья 4 в жидком состоянии, из которого получают кристаллический полупроводниковый материал. Расходуемый резервуар 5 образуется из материала, являющегося частью сырья 4. Материал, составляющий закрытый резервуар 5, является предпочтительно полупроводниковым материалом, который подлежит расплавке. Этот полупроводниковый материал может быть легированным или не легированным. Тем не менее, также возможно для закрытого резервуара 5 быть образованным из другого материала, например из легирующей примеси, подлежащей включению. В предпочтительном варианте осуществления, расходуемый резервуар 5 образован из материала,который имеет температуру плавления, близкую или равную температуре плавления основного компонента сырья 4, подлежащего расплавлению. Таким образом, расходуемый резервуар 5 не разрушается до того, как он окружен и/или покрыт достаточным количеством расплавленного материала, происходящего из сырья 4. В предпочтительном варианте размеры расходуемого резервуара 5 выбирают так, что выделение легирующих материалов 6 происходило тогда, когда присутствует достаточное количество расплавленного материала. Размеры резервуара зависят от гранулометрии легирующего вещества. Предпочтительно объем резервуара 5 составляет от нескольких кубических миллиметров до нескольких кубических сантиметров. Тем не менее, большие размеры могут быть использованы даже если становится предпочтительнее работать с несколькими резервуарами 5. После того, как сырье 4 полупроводникового материала было помещено в тигель 1 с закрытым резервуаром 5, содержащим одно или несколько легирующих веществ, сырье 4 подвергают расплавлению. Расходуемый резервуар 5 также расплавляют, что приводит к выделению легирующих веществ 6, введенных внутрь резервуара 5. Таким образом, легирующие примеси 6 введены в ванну расплава внутри тигля 1. Все содержимое тигля 1 расплавляют и используют для формирования кристаллических полупроводниковых материалов. Использование закрытого расходуемого резервуара 5, содержащего по меньшей мере одну легирующую примесь 6, является особенно выгодным. Легирующая примесь 6 может находиться в индивидуальном состоянии или в виде сплава. Когда расходуемый резервуар 5 имеет идентичную или практически идентичную температуру плавления, что и остальное сырье 4, легирующий материал 6 вводят непосредственно в расплавленное сырье 4. Это значительно уменьшает проблемы испарения легирующих материалов, когда существует градиент температуры тигля 1, например, когда примеси имеют более низкую температуру плавления,чем у полупроводниковых материалов, составляющих сырье, в которое необходимо провести включение. Этот вариант осуществления может быть улучшен путем создания расходуемого резервуар 5 герметически изолированным. Использование изолированного резервуара является еще более выгодным, когда тигель 1 находится в корпусе 7 при давлении ниже атмосферного и даже в вакууме. В качестве примера этот вариант осуществления особенно выгоден, когда рабочее давление составляет от атмосферного давления до 10-5 мбар. Работа при низком давлении является трудной или даже невозможной, когда она нацелена на включение легирующих веществ 6, имеющих высокое давление насыщенных паров, например галлия или фосфора. Далее, возможно выполнять повышение температуры сырья 4 при пониженном давлении, как правило, в диапазоне давлений, указанном выше, так, чтобы исключить паразитные примеси и затем выполнить плавление при более высоком давлении в целях предотвращения испарения легирующих примесей 6, намеренно введенных в сырье 4. Поскольку легирующие примеси 6 помещают непосредственно в ванну расплава, их введение в полупроводниковый материал поддается лучшему контролю. Это приводит к большей точности в количестве примесей, присутствующих в окончательном материале, поскольку снижаются потери, а также приводит к большей однородности примесей в ванне расплава и, следовательно, в кристаллизованном материале. Кроме того, легирующие примеси 6, будучи введенными в тигель 1 до шага плавления, устраняют необходимость вводить их в процессе способа плавления, что исключает риск загрязнения, когда примеси вносят, например, при помощи палочки. Это также приводит к упрощению оборудования, используемого для выполнения плавления сырья 4. Расходуемый резервуар 5, содержащий примеси 6 может быть использован в большом количестве технологий, которые включают размещение твердого материала в тигле, плавление этого твердого материала и затвердевание последнего. Обычные примеси полупроводникового материала могут быть введены в расходуемый резервуар 5,например, бор, фосфор, галлий, индий и германий. В преимущественном варианте примеси, имеющие низкую температуру плавления по сравнению с оставшейся частью сырья и/или имеющие равновесное давление паров, несовместимое со способом плавки, заключают в расходуемый резервуар 5. Расходуемый резервуар 5 производят любым подходящим способом, например путем нарезки блока полупроводникового материала, составляющего сырье 4, или с помощью другой техники машинной обработки. Расходуемый резервуар 5 может быть образован из чистого материала, сплава или легированного материала. Легирующее вещество 6, содержащееся в расходуемом резервуаре 5, представляет собой отличный материал от материала резервуара. В предпочтительно варианте примесь 6 является чистым или в большей степени чистым материалом. В предпочтительном варианте расходуемый резервуар 5 расположен внутри сырья 4, а не в контакте с нижней 2, боковыми стенками 3 и верхней частью шихты. Еще более предпочтительным образом расходуемый резервуар 5 расположен между верхней третью и нижней третью сырья 4, подлежащего расплавлению. Это позволяет осуществить отложенное плавление расходуемого резервуара 5 по сравнению с сырьем 4. Кроме того, можно расположить резервуар в нижней трети, чтобы не допустить слишком легкого всплывания резервуара. В альтернативном варианте осуществления расходуемый резервуар или расходуемые резервуары размещают в сырье после этапа плавления. Таким образом, примеси вводят после плавления шихты. Как и в различных вариантах осуществления, резервуары могут вводить отличные друг от друга легирующие вещества или смеси легирующих веществ в целях предотвращения паразитных реакций. Резервуар позволяет осуществить лучшее введение примесей в центр сырья перед переходом в расплавленное состояние. Поскольку количество легирующего вещества, теряемого из-за испарения, уменьшается, то можно получить кристаллический полупроводниковый материал с такой добавленной концентрацией примеси,которая является очень низкой и очень хорошо управляемой. ФОРМУЛА ИЗОБРЕТЕНИЯ 1. Способ легирования полупроводникового материала, содержащий следующие этапы: обеспечение тигля (1), содержащего сырье (4) упомянутого полупроводникового материала,размещение легирующего материала (6) в закрытом расходуемом резервуаре (5 а), образованном упомянутым полупроводниковым материалом,помещение резервуара (5 а) в тигель (1),плавление содержимого тигля (1). 2. Способ по п.1, согласно которому закрытый расходуемый резервуар (5 а) выполнен герметичным. 3. Способ по п.1 или 2, согласно которому тигель (1) помещают в корпус (7), в котором создают давление ниже атмосферного. 4. Способ по любому из пп.1-3, согласно которому закрытый расходуемый резервуар (5 а) располагают в нижней трети сырья (4) полупроводникового материала. 5. Способ по любому из пп.1-4, согласно которому используют дополнительный расходуемый резервуар (5b), размещаемый в том же тигле (1). 6. Способ по п.5, согласно которому расходуемый резервуар (5 а) и дополнительный расходуемый резервуар (5b) выполнены из материалов с различными температурами плавления.
МПК / Метки
МПК: C30B 11/04
Метки: легирования, материала, способ, полупроводникового
Код ссылки
<a href="https://eas.patents.su/5-23641-sposob-legirovaniya-poluprovodnikovogo-materiala.html" rel="bookmark" title="База патентов Евразийского Союза">Способ легирования полупроводникового материала</a>
Предыдущий патент: Бытовой прибор для сушки белья и способ определения степени сухости белья, подвергаемого сушке в этом приборе
Следующий патент: Гетеробициклические производные в качестве ингибиторов hcv
Случайный патент: Состав для печати изображения на поверхности изделия каучукового латекса, способ печати изображения и изделия из каучукового латекса









